中国粉体网讯 随着智能制造和物联网的发展,电子系统的封装密度呈指数式增加;另一方面,大功率系统如大功率LED和IGBT等在工业和日常生活中变得不可或缺,这些应用需求都对未来电子封装技术提出了极大的挑战。
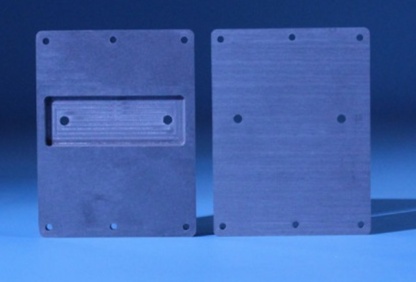
SiCp/Al散热片,来源:钧杰陶瓷
SiCp颗粒性能优异,成本低廉,具有低密度(ρ=3.2g•cm-3)、低热膨胀系数(α=4.0×10-6K-1)、高杨氏模量(E=221GPa)等优点,而且高纯SiC的TC可达200W•m-1•K-1。Al作为基体材料,是强度的主要载体,具有高导热(170W•m-1K-1~220W•m-1K-1)、低密度(2.7g•cm-3)、价格低廉和易于加工等优点。将SiC和Al制备成复合材料后,结合了两者各自的优点,能发挥出“1+1>2”的综合性能优势,如优异的热物理性能、力学性能、摩擦磨损性能等,在电子封装、航空航天、核电等领域能获得广泛应用。
从80年代开始,国外对SiCp/Al电子封装复合材料的研究已经从试验阶段步入实用阶段,首先在航空航天、光学、仪表等领域取得了实际应用。在军用方面,已经有多种电子产品采用了这种材料,如混合电路(HIC)、多芯片组(MCM)的热沉和超大功率模块(IGBT)的封装等,都获得了不错的效果。美国F-22“猛禽”战斗机上的遥控自动驾驶仪、发电单元、抬头显示器、电子计数测量阵列等关键电子系统上,替代包铜的钼作为印刷电路板板芯,取得了减重70%的显著效果。由于此种材料的导热率高达180W/(m•K),从而降低了电子模块的工作温度,减少了冷却的需要,还被用于F-22战斗机的电子元器件基座及外壳等热控结构。此外,SiCp/Al复合材料还可以代替W/Cu合金应用于相控阵雷达的微波功率管封装底。在民用方面,美国CPS公司采用压力熔渗法生产的SiCp/Al电子封装产品如封装外壳、大功率IGBT基板和高亮度LED基板等,已大量投入市场。国内也已有公司采用无压渗透工艺生产出3mm×3mm×0.5mm~150mm×150mm×10mm的SiCp/Al系列基板材料。
虽然SiCp/Al电子封装复合材料具有良好的综合性能,原料来源广泛,价格较低,但由于SiC与Al之间的润湿性较差,SiCp/Al复合材料的制备工艺成为应用瓶颈。因此目前还主要用于军工领域,而降低制造成本是研究和开发SiCp/Al复合材料面临的关键问题。
在此背景下,中国粉体网将于2023年3月9-10日在江西萍乡举办“2022第五届新型陶瓷技术与产业高峰论坛”,我们邀请到湖南大学肖汉宁教授将作题为《碳化硅/铝复合材料的制备及其在电子封装中的应用》的报告。届时,肖汉宁教授将对SiCp/Al复合材料及其在电子封装中的应用进行介绍,并对其关键制备技术进行详细阐述。

(中国粉体网编辑整理/山川)
注:图片非商业用途,存在侵权告知删除


















