中国粉体网讯 有机材料基板加工难度小,生产成本较低,在芯片封装领域已被应用多年,但随着高性能芯片的发展,有机材料基板在信号传输速度、功率传输效率以及封装基板的稳定性上呈现出一定的局限性。由此,玻璃基板应运而生。
玻璃基板作为下一代芯片基板,核心材料由玻璃制成。其介电常数低,可降低信号损耗与干扰,提升传输速度;热膨胀系数与硅相近,热稳定性佳,能减少热应力;平整度和机械稳定性好,利于高密度集成;还可实现大尺寸生产,降低单位制造成本,契合高性能芯片的先进封装需求。
在全球科技企业纷纷聚焦玻璃基板技术的大背景下,国内企业也积极投身其中,全力抢占这一新兴领域的发展高地。

深圳市深光谷科技有限公司是专注于光通信芯片与器件的研发、设计、生产与销售的国家高新技术企业。
近日,深光谷科技联合上海交通大学和深圳大学,合作开发了晶圆级TGV光电interposer工艺,实现了国产首个8英寸晶圆级TGV interposer加工,实测带宽达到110GHz,可以面向2.5D和3D光电集成封装应用,为VCSEL、DML、EML、硅光、铌酸锂等技术路线的光模块产品提供高速、高密度、高可靠性和低成本的光电共封装(CPO)解决方案。


TGV晶圆和interposer芯片 来源:深光谷科技
深光谷科技所开发的TGV光电interposer采用激光诱导刻蚀结合多层重布线(RDL)工艺,通孔深宽比4:1,基板厚度230um,表面平整度1.2um,支持2+1层RDL,挖槽深度60um,支持光纤阵列的耦合对准,支持电芯片flipchip封装,支持EML/SOA/硅光/铌酸锂等光芯片植球倒装,实测通孔和RDL布线带宽超过110GHz。

通孔电镜和RDL结构 来源:深光谷科技

奕成科技是一家集成电路领域板级系统封测服务的提供商,主要从事集成电路板级先进系统封测业务,经过持续研发积累,奕成科技已汇聚全球半导体先进封测技术核心团队,独创的板级高密系统封测技术,可对应2D FO、2.xD FO、FO PoP、FCPLP等先进系统集成封装。
在技术专利上,奕成科技拥有“芯片封装结构及封装方法”“带导电通孔的玻璃基板及其制作方法”“TGV转接板”等多项专利,在减少信号损失、提升玻璃通孔性能与可靠性、增强转接板强度等方面有显著成效。在产品量产上,是国内玻璃面板级封装首批量产厂家之一,其FOMCM技术平台具有高密度大尺寸集成、广泛应用和可控成本等优势。
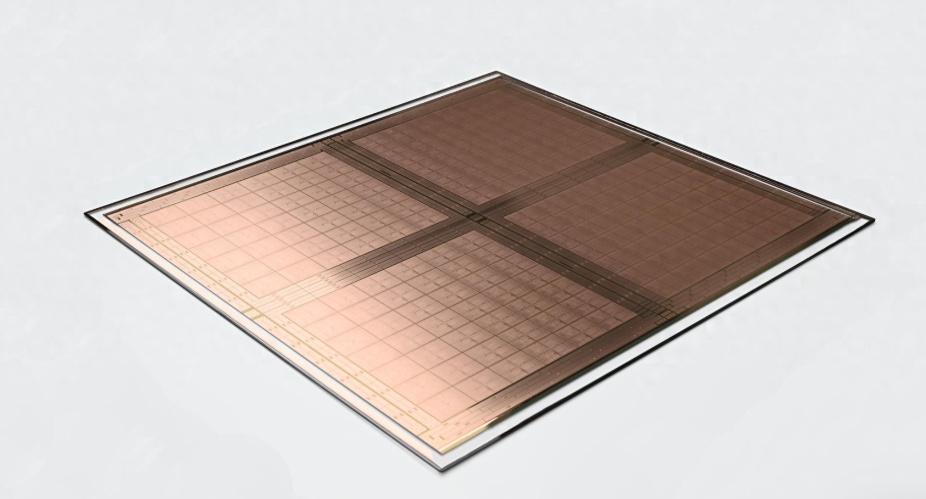
板级高密FOMCM封装产品 来源:奕成科技

通富微电是集成电路封装测试服务提供商,其产品、技术、服务全方位涵盖网络通讯、移动终端、家用电器、人工智能和汽车电子等领域。
公司基于玻璃基板布局的倒装芯片球栅阵列(FCBGA)封装技术具有显著优势,可应用于高性能计算、5G通信,能提供更好的信号完整性和信号路由能力,实现更高的互连密度,满足AI芯片、高性能处理器等对高集成度、高算力的需求。

FCBGA 技术产品 来源:通富微电

江西沃格光电是中国领先的玻璃基线路板及相关电子器件研发、制造企业。是全球目前极少数拥有全制程工艺能力和制备装备的公司。
其自主研发的玻璃基线路板技术具备全球领先的TGV玻璃基板加工能力,可实现通孔孔径最小至3微米,深径比高达150:1,支持高达四层的线路堆叠,能替代传统硅基TSV技术。

玻璃基封装载板 来源:沃格光电
参考来源:
沃格光电、Absolics、通富微电、深光谷科技、奕成科技
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!


















