中国粉体网讯 半导体设备可分为前道设备(晶圆制造)和后道设备(封装与测试)两大类。前道设备投资量占总设备的80%以上,刻蚀设备、薄膜沉积设备和光刻机分别占前道设备价值量的22%、22%和17%,是半导体前道生产工艺中的三大核心设备,决定了芯片制造工艺的先进程度。
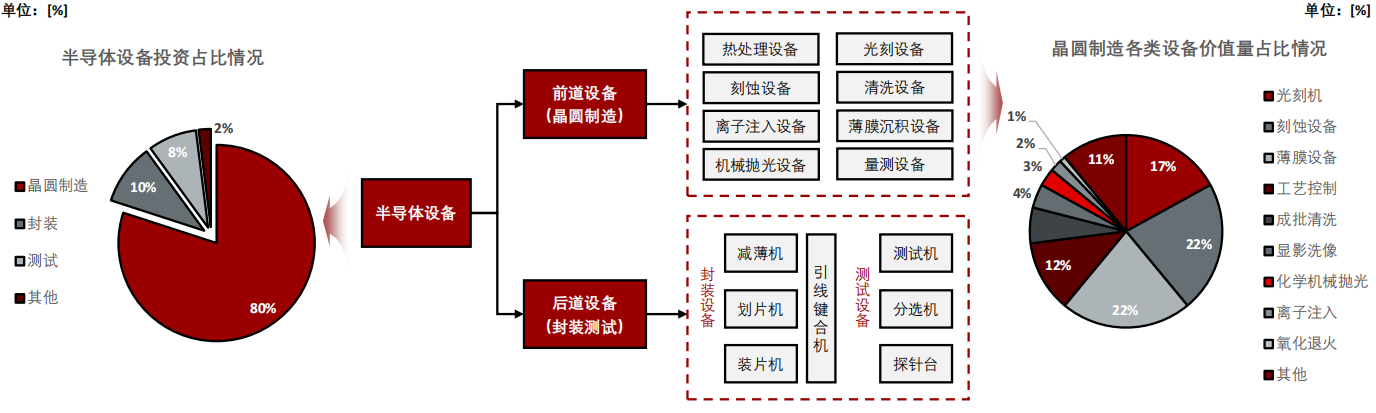
来源:SEMI、头豹研究院
薄膜沉积、光刻、刻蚀被视为半导体制造的三大核心设备,其中薄膜沉积是基础,其作用是在晶圆表面通过物理/化学方法交替堆叠SiO2、SiN等绝缘介质薄膜和Al、Cu等金属导电膜等,在这些薄膜上可以进行掩膜版图形转移(光刻)、刻蚀等工艺,最终形成各层电路结构。由于制造工艺中需要薄膜沉积技术在晶圆上重复堆叠薄膜,因此薄膜沉积技术可视为前道制造中的“加法工艺”。
2023年晶圆制造设备销售额约占总体半导体设备销售额的90%,达到约960亿美元,全球薄膜沉积设备市场规模约为211亿美元。
薄膜沉积设备所沉积的薄膜是芯片结构内的功能材料层,在芯片制造过程中需求量巨大,直接影响芯片的性能。不同芯片结构所需要的薄膜材料种类不同、沉积工序不同、性能指标不同,相应产生了巨大的薄膜沉积设备市场。目前主流的薄膜沉积设备有物理气相沉积(PVD)、化学气相沉积(CVD)、原子层沉积(ALD)。三种薄膜沉积工艺在沉积原理、沉积材料、适用膜层及工艺等方面存在明显差异,凭借各自的特性搭配完成集成电路制造流程中的薄膜沉积。
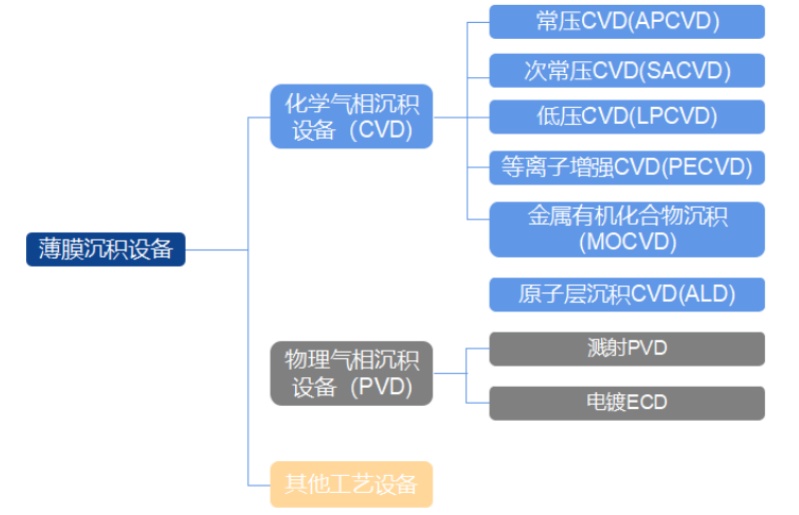
薄膜沉积设备分类
随着半导体制造技术的不断发展,对薄膜沉积设备的要求也越来越高。先进陶瓷作为新型材料,其性能的不断提升和新型陶瓷材料的开发,为半导体制造技术的发展提供了有力支持。
陶瓷加热器
晶圆在加热过程中至关重要,温度的均匀性不仅影响产品的良率,还直接决定薄膜沉积、刻蚀等关键工艺的质量。陶瓷加热器是半导体薄膜沉积设备中的关键组件,它直接应用于工艺腔体中,与晶圆直接接触,不仅承载晶圆,还可以在成膜流程中均匀控制晶圆温度。
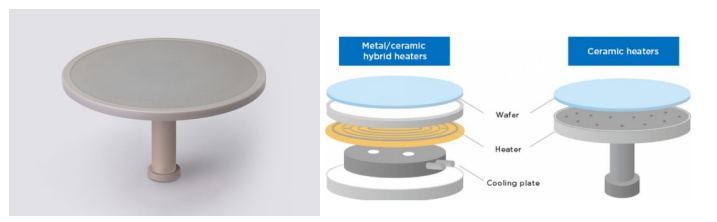
陶瓷加热器,来源:NGK、住友电工
基于该设备高温的使用环境,通常选用以氮化铝(AlN)为主的陶瓷材料,AlN不仅具有高导热性,能够在短时间内实现快速升温和降温,还具有良好的电绝缘性和机械强度,确保了加热器的稳定性和可靠性。此外,氮化铝的热膨胀系数与硅相近,这有助于减少热应力对晶圆的影响,提高工艺良率。
陶瓷加热器的构造包含陶瓷基体(具有晶圆载放面)、圆筒形支撑体(提供支承),在陶瓷基体内部或表面,设置有电阻发热体电路(用于加热)、RF电极和静电卡盘用电极等导电体。支撑体内设置有热传导气体进出管道,保证加热盘的释放的温度均匀,陶瓷基体和支持体利用接合层进行化学接合。通过精确控制加热器的温度,可以确保晶圆表面温度在±1.0%以内波动,甚至一些高端加热器如日本碍子(NGK insulator)的产品,温度波动可以控制在0.1%以内,这是实现高质量薄膜沉积的关键。
陶瓷喷嘴
HDP-CVD是一种利用电感耦合等离子体(ICP)源的化学气相沉积设备,是一种越来越受欢迎的等离子体沉积设备。
在HDP-CVD中,反应气体是通过连接腔体内外的陶瓷喷嘴进入到反应腔内的,因此喷嘴的品质会直接决定反应气体的纯度和流速。常用来制备陶瓷喷嘴的材料有氧化铝和氮化铝,由于氮化铝陶瓷的热导率和抗热震性比氧化铝更好,喷嘴不会因为等离子体腐蚀产生杂质污染,也不会因为热形变造成装配部件的磨损带来杂质污染,从而确保喷嘴不会对反应气体和反应腔体造成任何的杂质污染风险,可以更好地满足先进制程HDP-CVD设备中的应用要求。

氧化铝喷嘴、氮化铝喷嘴,来源:卡贝尼
静电卡盘
静电卡盘作为半导体刻蚀、薄膜沉积、离子注入等关键设备中的核心部件,其需求也将相应增加。例如,在先进制程的刻蚀工艺中,需要静电卡盘提供更强大的静电吸附力和更精准的温度控制,以确保晶圆在刻蚀过程中的稳定性和位置精确度。
静电卡盘对于执行需要在不破坏真空的情况下进行对基板表面的加热和冷却两者的等离子体辅助干法蚀刻处理来说尤其有用。另外,静电卡盘可有用于在基板上执行薄膜沉积工艺。静电卡盘通过静电吸附原理,利用电场产生的静电力将硅晶圆或其他基底材料牢固地固定在其表面,防止在处理过程中发生移动,确保薄膜沉积的精确性和一致性。
随着半导体工艺的发展,传统陶瓷加热器与静电卡盘的界限逐渐模糊,一些先进的陶瓷加热器已经具备高温加热和静电吸附的双重功能,为半导体制造提供了更多的可能性。而用于刻蚀设备的静电卡盘也开始涉及高温制程,陶瓷材料就要从氧化铝转变为氮化铝。
陶瓷腔体罩
陶瓷腔体罩是包括陶瓷dome、冷却系统、电极控制系统的一体化独立功能部件,是40nm及以下所有制程的薄膜沉积设备中关键部件之一,其性能对保证晶圆品质至关重要。
陶瓷腔体罩覆盖在晶圆上部,将CVD设备腔体进行密封,形成封闭的腔室环境,在钟形罩周围有线圈的天线构件,可以施加高频功率形成感应电场来产生ICP(等离子体),并通过陶瓷腔体罩引入腔室内部,进行等离子处理并保护淀膜进程的顺利进行。陶瓷腔体罩对保证反应腔室的密封性、内外压差、反应腔内洁净度等起到关键作用,是CVD设备最为关键的核心部件之一。
来源:
陶近翁等:半导体陶瓷零部件种类及应用
肖心怡:半导体薄膜沉积设备,国产替代持续推进(久阳润泉投研团队)
微纳研究院:【微纳加工】陶瓷加热器在薄膜沉积中的关键作用
珂玛科技招股书
(中国粉体网编辑整理/空青)
注:图片非商业用途,存在侵权告知删除


















