中国粉体网讯 近日,国家知识产权局信息显示,华为技术有限公司一项名为“一种铜金刚石散热基板”的专利正式获得授权(授权公告号CN223110366U),申请日期为2024年7月,涉及散热基板技术领域,旨在通过材料与结构创新突破高功率器件的散热瓶颈。

专利提供了一种铜金刚石散热基板,包括铜金刚石复合层、第一金属层、第二金属层,铜金刚石复合层包括铜金刚石材料以及金属框,铜金刚石材料设置于金属框的通孔中,第一金属层设置于铜金刚石复合层的上层,第二金属层设置于铜金刚石复合层的下层,其特征在于,第一金属层通过第一焊料层与铜金刚石复合层固定连接,第二金属层通过第二焊料层与铜金刚石复合层固定连接。
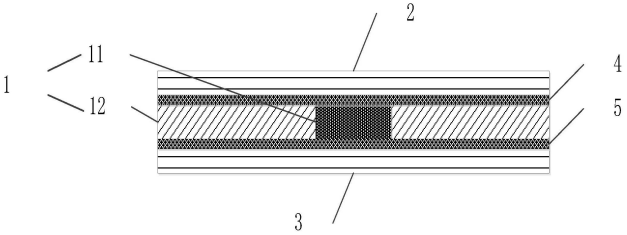
传统工艺采用预压烧结制备的同类结构,普遍存在界面结合强度不足的问题,易导致散热效能衰减或结构损坏。而华为的设计通过两大优化解决这一痛点:一方面,金属框结构对金刚石颗粒形成有效封装,避免颗粒脱落或位移;另一方面,焊料层形成的冶金结合强化了界面连接,既保留了铜的高导热特性和金刚石的低热膨胀优势,又显著提升了整体结构的机械稳定性。
华为金刚石散热领域的进阶之旅
近年来,华为在金刚石散热这一领域持续发力,不断斩获重要成果,取得了显著的进展。
2023年3月,华为用于芯片散热的两项复合导热材料专利公布。其中一个技术方案以金刚石颗粒材料为主要散热材料,涉及复合导热材料的电子设备、金刚石基导热填料及其制备方法。所述复合导热材料的导热系数高且维持良好可应用性。
2023年11月,华为与哈尔滨工业大学联合申请“基于硅和金刚石的三维集成芯片混合键合方法”专利,通过Cu/SiO2混合键合技术将硅基与金刚石衬底进行三维集成。该技术优化了界面结合强度,解决了传统硅基材料热导率低的问题,为高功率芯片构建高效散热通道,助力提升器件可靠性。
2024年2月,华为与厦门大学、厦门云天团队合作,在先进封装玻璃转接板集成芯片-金刚石散热技术领域取得突破性进展。这项研究将金刚石低温键合与玻璃转接板技术相结合,首次实现了将多晶金刚石衬底集成到玻璃转接板封装芯片的背面。
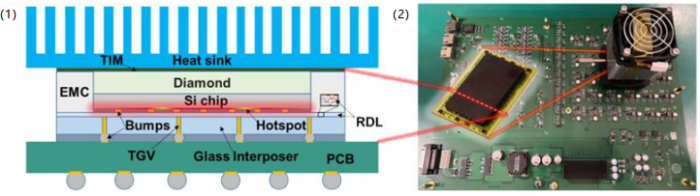
(1)集成金刚石-芯片-玻璃转接板(DoCoG)的结构示意图,(2)DoCoG封装热测试配置照片,图源:Heterogeneous Integration of Diamond-on-Chip-on-Glass Interposer for Efficient Thermal Management
2024年12月,华为技术有限公司公布一项名为“一种半导体器件及其制作方法、集成电路、电子设备”的发明专利。通过增加金刚石散热层与钝化层的接触面积,改善金刚石散热层与钝化层之间的结合力,并且减小金刚石散热层与栅极之间的热扩散距离,提高半导体器件的散热效率。
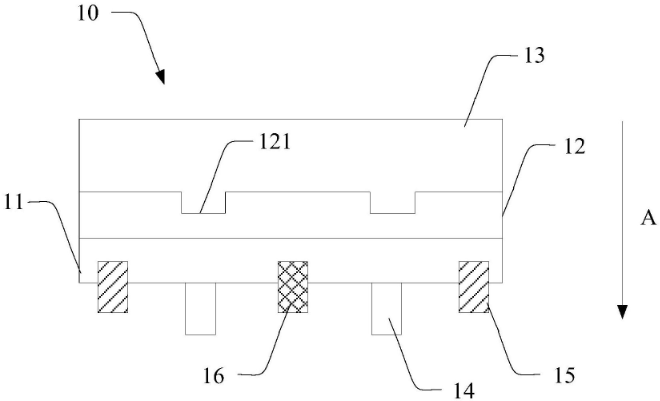
10-半导体器件、11-第一外延层、12-钝化层、13-金刚石散热层、14-栅极、15-源极、16-漏极、121-凹槽
华为在金刚石散热这一领域持续发力,从键合技术、复合导热材料到芯片集成结构设计等多个方面进行创新。通过与高校、科研团队的紧密合作,成功解决了诸多技术难题,不断提升散热效率。随着技术的进一步成熟和应用,相信金刚石将在半导体散热领域发挥越来越重要的作用,为手机、电脑等产品的散热问题提供更为高效的解决方案。
参考来源:国家知识产权局、Flink未来产链
(中国粉体网编辑整理/石语)
注:图片非商业用途,存在侵权请告知删除!

















