中国粉体网讯 过去数十年,半导体产业的发展始终以摩尔定律为核心指引,通过持续缩小晶体管特征尺寸,芯片的集成度与性能实现了跨越式提升,成为数字经济时代的核心驱动力。然而,当晶体管尺寸逐渐逼近物理极限,传统二维缩放模式不仅面临量子隧穿、漏电等物理瓶颈,还遭遇了制造成本指数级攀升的经济性挑战。在此背景下,产业战略重心加速转向异构集成、2.5D/3D封装等先进封装技术,通过将多个功能各异的芯片或芯粒集成于单一封装体内,实现系统性能的持续提升、功耗的有效降低与设计的灵活迭代,成为后摩尔时代延续芯片性能增长轨迹的关键路径。
随着高性能计算(HPC)、人工智能(AI)及数据中心等领域的快速发展,封装平台面临更高要求,亟需实现极高的互连密度、极低的信号延迟与功耗,同时控制封装成本。在这类技术需求的驱动下,玻璃通孔(TGV)技术应运而生。该技术以具备优异电学与热机械性能的玻璃基板为依托,通过制备垂直贯穿的导电通道,为芯片间、芯片与封装基板间构建起最短的电信号与电源传输路径。这种垂直互联方式不仅大幅缩短信号延迟、降低功耗,还推动系统级封装向极致小型化演进。目前,基于TGV技术的封装解决方案主要沿两条路径发展,且在更先进的封装架构中,这两条路径并非完全独立,甚至可实现有机融合。
第一条路径是TGV玻璃转接板,作为异构集成的关键核心组件,它也被称为中介层,是当前研发进程最快、市场需求最迫切的技术方向之一。玻璃材料本身具备优异的平整度与稳定性,其热膨胀系数(CTE)约为3×10-6/°C,与硅芯片更为匹配,能有效缓解封装过程中的热应力问题。典型的TGV转接板厚度为400μm,最小通孔间距可达到35~40μm,凭借高密度布线能力,它能够精准连接不同节距的芯片与基板,实现逻辑芯片、高带宽内存(HBM)等多类集成电路的高效集成。在AI芯片、高性能计算芯片对异构集成需求日益迫切的当下,TGV玻璃转接板凭借其优异的电气性能与成本潜力,成为破解多芯片集成互连瓶颈的核心方案。
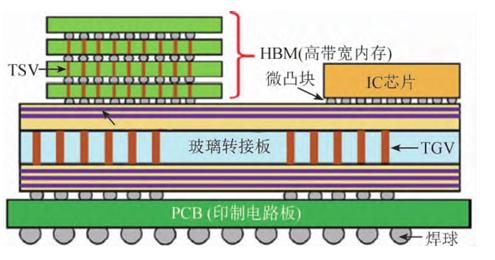
先进封装中的TGV玻璃转接板 来源:《TGV技术发展现状与未来挑战》(李圣斌等)
第二条路径是TGV玻璃芯板(GCS),作为传统树脂IC封装基板(如FC-BGA基板)的颠覆性替代品,近年来成为产业研发的热点方向。与玻璃转接板不同,GCS以玻璃为核心材料直接制成IC封装基板,可直接承载芯片并连接至最终的印刷电路板(PCB),其热膨胀系数约为7×10-6/°C,典型厚度为800μm,典型通孔间距为100μm。该技术从根本上突破了有机基板在尺寸、翘曲控制及布线密度方面的固有瓶颈,能够支撑更大尺寸、更高密度的多芯粒系统集成,为超大规模芯片封装提供了全新可能。不过,受限于制造工艺复杂度与成本控制难度,GCS技术目前仍处于早期商业化阶段,尚未实现大规模量产应用。

多芯片模块封装中的TGV玻璃芯板 来源:《TGV技术发展现状与未来挑战》(李圣斌等)
值得注意的是,为追求更高层次的封装性能与可靠性,业界已开始探索玻璃转接板与玻璃芯板相结合的“全玻璃”堆叠技术路径。通过这种一体化堆叠结构,能够进一步优化整个封装系统的热膨胀系数匹配度,有效缓解多材料集成带来的热应力问题,提升封装系统的长期稳定性,尤其适用于对可靠性要求极高的高端芯片应用场景。
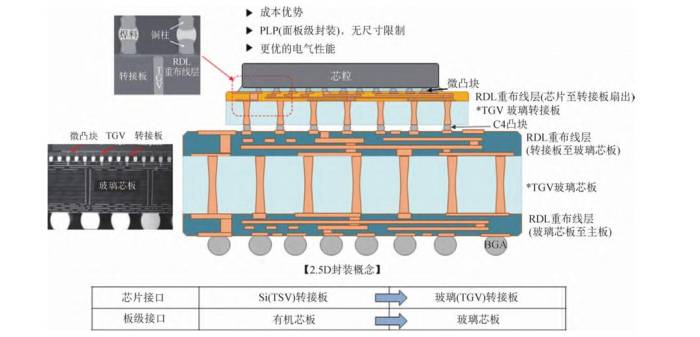
全玻璃封装 来源:Doyoung Kim.Not a Replacement,But a Rival Class: Why Glass Interposers Still Matter
从产业发展逻辑来看,玻璃基板之所以能成为全球半导体产业链的共同战略选择,核心在于其完美契合了后摩尔时代芯片封装的核心需求——更高密度、更低延迟、更低功耗与更高可靠性。尽管目前玻璃基板技术仍面临制造工艺优化、成本控制等挑战,但在全球产业力量的协同推动下,相信相关技术瓶颈会被逐步攻破。
总体而言,在摩尔定律趋缓的大背景下,先进封装与互连技术已成为驱动芯片性能增长的核心引擎,而以TGV技术为核心的玻璃基板路线,正引领着这场产业变革的方向。从技术研发到量产落地,从单一应用到融合创新,玻璃基板正逐步解锁下一代芯片的性能潜力,为半导体产业的持续发展注入全新动能,也将深刻影响全球数字经济的发展进程。
参考来源:
李圣斌.TGV技术发展现状与未来挑战
Doyoung Kim.Not a Replacement,But a Rival Class: Why Glass Interposers Still Matter
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!

















