中国粉体网讯 TGV技术是近年来在先进封装(如2.5D/3D IC、射频器件、MEMS、光电子集成等)领域备受关注的关键工艺。相较于传统的硅通孔(TSV)和有机基板,玻璃基板凭借其优异的高频性能、低介电损耗、高平整度及热稳定性,成为新一代封装材料的理想选择。而TGV成孔技术则是实现玻璃基板互连的核心环节,如何制备出高深宽比、窄节距、高垂直度、高侧壁粗糙度、低成本的玻璃通孔一直是多年来各种研究工作的重心。目前主流的玻璃通孔加工成型方法有喷砂法、聚焦放电法、等离子刻蚀法、电化学放电法、光敏玻璃法等。
喷砂法
加工步骤:喷砂法要求在加工前先在玻璃基板上制作一层复合掩模,然后以制备的复合掩模为基础,采用干粉喷砂工艺对玻璃晶片进行蚀刻。可在玻璃晶片的一侧先蚀刻一次,随后在玻璃晶片的另一侧也采用同样的工艺步骤进行蚀刻,两次喷砂蚀刻过程中必须保证中心点完全对称以形成完整的通孔。
工艺特点:由于喷砂法制作的通孔非常粗糙,孔径较大且一致性较差,所以该方法只能制作孔径较大(>200μm)、间距较大的玻璃通孔,在先进封装工艺中使用较少。
聚焦放电法
加工步骤:将玻璃放在两个电极之间,通过控制放电对玻璃局部区域进行放电熔融,通过焦耳热使玻璃内部产生高应力,引起内部高压和介电击穿,上述步骤可以在不到1μs的时间内就完成100~500μm厚的玻璃通孔制备,可以制备最小孔径为20μm、深宽比5~8的玻璃通孔。
工艺特点:聚焦放电产生玻璃通孔的方法可以制备多种类型的玻璃,如石英、钠钙玻璃、无碱玻璃、含碱玻璃等,该方法能够制作均匀性较好、没有裂纹的高密度通孔。但由于此方法是单次进行单孔制作,所以生产效率较低,且从玻璃通孔的切片结果来看,通孔的形状不是很垂直,可能会影响后续填充的效果。
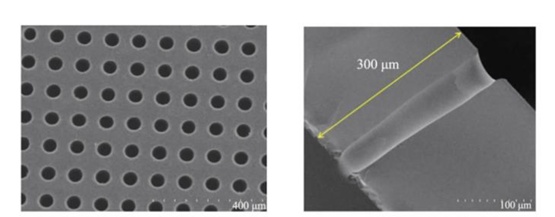
聚焦放电法制作的TGV阵列以及截面图 来源:《玻璃通孔技术研究进展》
等离子体刻蚀
加工步骤:在石英上蒸发沉积一层铝层作为刻蚀硬掩模,通过光刻的方法暴露出玻璃表面需要光刻的位置,用氯气或者三氯化硼腐蚀暴露的铝层,用氧气等离子体去除玻璃表面的光刻胶,利用全氟环丁烷/氩气等离子体蚀刻石英以形成TGV。
工艺特点:等离子体法刻蚀TGV可以同时进行大面积的多个TGV刻蚀,因此生产效率相较聚焦放电法可以得到改善,且因为其侧壁粗糙度小(<150nm)、侧壁无损伤,拥有良好的可靠性保证。但是等离子刻蚀TGV的方法也还存在许多缺点,包括工艺复杂,需要额外的多个步骤;生产成本高,需要用到掩膜版、光刻胶等。
电化学放电加工法
加工步骤:电化学放电加工法是一种将电火花加工(EDM)和电解加工(ECM)相结合的新型低成本玻璃微加工方法。将工具电极和对电极分别连接到电源的正、负端子上,当两个电极之间存在电位差时,工具电极周围会形成一层氢气膜将工具电极与周围的电解液完全隔离。当电位差进一步增大时,氢气膜破裂,产生电化学放电,并将玻璃融化并移除。
工艺特点:该方法不仅工艺简单,且对设备要求较低,能快速加工出TGV。但是目前该方法只能加工出孔径大于300μm且上开口大于下开口的锥形玻璃通孔,这也大大限制了该方法的应用范围。
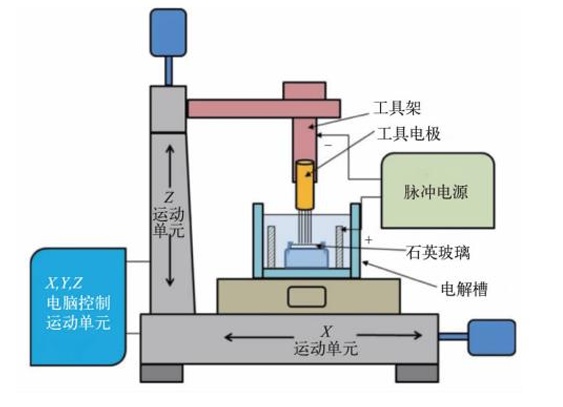
电化学放电法制备TGV装置 来源:广发证券
光敏玻璃法
加工步骤:光敏玻璃法是指根据光敏玻璃材料特性,利用紫外曝光、热处理、湿法刻蚀等方法实现玻璃通孔加工的工艺流程。加工前需先将玻璃进行预处理,即将玻璃先后放入异丙醇和丙酮中分别超声清洗10min取出后用氮气吹干,除去玻璃表面杂质,随后先通过紫外光对光敏玻璃进行曝光,并在马弗炉中进行热处理以让紫外线照射过的区域材料变性成为陶瓷材料,最后通过氢氟酸溶液进行湿法刻蚀来去除陶瓷材料,整个加工过程中需要精密的温度控制。
工艺特点:基于光敏玻璃的TGV制作方法优势在于采用高刻蚀速率的湿法腐蚀可以实现各向异性刻蚀,从而获得高密度、高深宽比的玻璃通孔。但是该技术也存在两个问题,首先是价格昂贵,光敏玻璃本身的材料价格和工艺制程价格都相对较高,其次是对于不同尺寸的图形,尤其是盲孔或者盲槽的刻蚀,由于腐蚀速率不同会造成图形定义精度差别较大。
激光诱导刻蚀法
加工步骤:使用皮秒激光在玻璃上产生变性区域,将激光处理过的玻璃放到氢氟酸溶液中进行刻蚀。
工艺特点:激光诱导刻蚀法的反应机理与光敏玻璃法类似,都是通过某种光线的照射使得玻璃内部出现变性区域,然后通过酸溶液湿法刻蚀完成,区别在于激光诱导刻蚀法无需使用特殊的光敏玻璃。
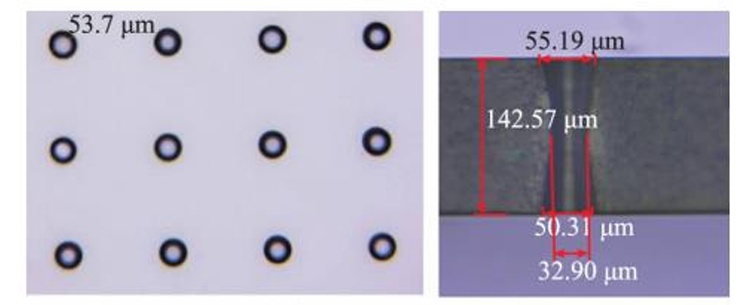
激光诱导刻蚀制作的TGV阵列以及截面图 来源:广发证券
TGV成孔作为玻璃基板应用于先进封装的核心技术,直接决定了玻璃基板的商业化前景。未来,伴随着更多玻璃基板先进成孔技术的诞生,半导体先进封装领域也势必会有突破性的进展。
参考来源:
王刚.三维集成封装中光敏玻璃通孔制备工艺研究
陈力.玻璃通孔技术研究进展
广发证券发展研究中心
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!

















