中国粉体网讯 化学机械抛光(CMP)技术能够消除芯片表面的高点及波浪形。CMP通过抛光液中化学试剂的化学腐蚀和机械磨削的双重耦合作用,在原子水平上去除表面缺陷,获得全局平坦化表面,因此,抛光液对抛光效果起到至关重要的影响。
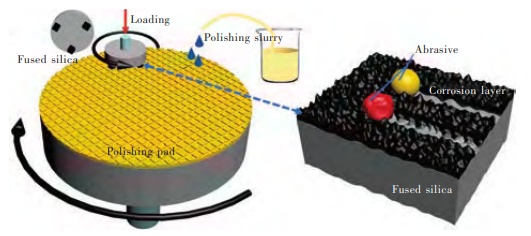
CMP工艺 来源:何潮等,半导体材料CMP过程中磨料的研究进展
CMP抛光液作为影响化学机械抛光质量和抛光效率的关键因素,其组分一般包括磨料、氧化剂和其它添加剂。添加剂一般包括络合剂、螯合剂、缓蚀剂、表面活性剂,以及pH调节剂等。通常根据被抛光材料的物理化学性质及对抛光性能的要求,来选择所需的成分配置抛光液。
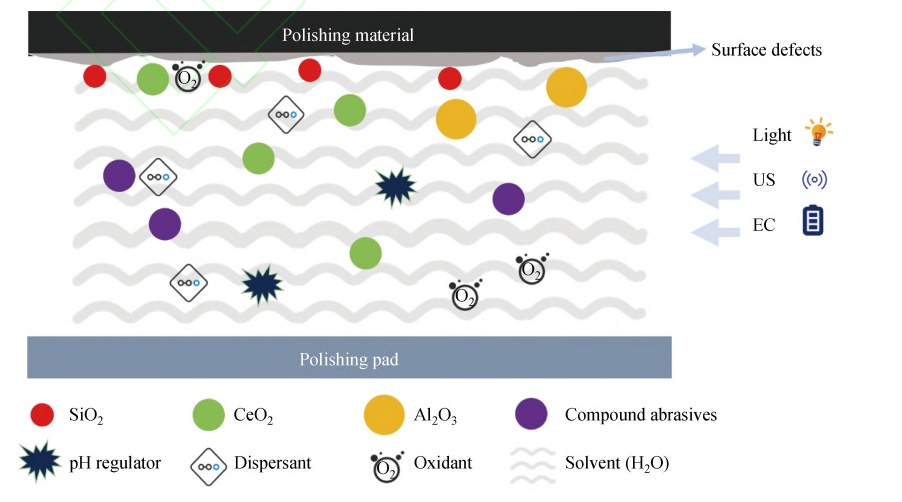
化学机械抛光液各组分 来源:王东哲等,化学机械抛光液的研究现状
化学机械抛光液各组分
1. 磨料
作用:磨料是CMP抛光液中最直接参与去除材料的部分。它们通过物理摩擦作用,帮助去除工件表面因氧化剂反应生成的软质薄膜。
粒径和硬度的影响:
粒径:磨料的大小直接影响到抛光效率和表面质量。过大粒径会增加划痕和其他表面损伤的风险;而过小粒径虽然可以提供更好的表面光滑度,但会显著降低材料去除率。
硬度:磨料的硬度需要与被抛光材料相匹配。过硬可能导致表面刮伤或产生更多缺陷;过软则会导致材料去除率低下。
选择:根据具体应用场景选择合适的磨料类型(如SiO2、Al2O3、CeO2等),并精确控制其粒径分布及硬度。

不同尺寸的CeO2颗粒
来源:范永宇,CeO2复合磨料制备及其在化学机械抛光中的应用
2. pH调节剂
作用:通过调整抛光液的酸碱度来优化化学反应条件,确保化学反应按照预期进行。
酸性抛光液:适用于金属材料抛光,具有较强的溶解能力和较高的抛光效率。然而,它对设备有较高要求,并可能缺乏良好的选择性。
碱性抛光液:更适合非金属材料,拥有较好的选择性和较低的腐蚀性,但在寻找高效氧化剂方面存在挑战。
应用:根据待抛光材料特性和所需表面特性选择适当pH值范围内的抛光液。
3.氧化剂
作用:氧化剂与工件表面发生化学反应,形成一层容易被机械移除的软质物质,从而实现高效且均匀的材料去除。
重要性:正确选择氧化剂对于保证抛光过程的有效性和最终产品质量至关重要。不同材料对应不同的最佳氧化剂。
考虑因素:除了活性外,还需要考虑到与其他成分之间的兼容性以及对环境的影响等因素。
4.抑制剂
作用:抑制剂用来控制化学侵蚀的程度,使得整个抛光过程更加可控和平稳。它可以提高局部区域的选择性蚀刻效果,同时减少对设备本身的损害。
效果:通过添加特定类型的抑制剂,可以在一定程度上改善抛光液的选择性,使其能够更好地适应复杂结构的处理需求。
5.表面活性剂
选择合适的表面活性剂可以同时起到磨料分散、表面润湿、去污、腐蚀抑制等多种效果,应用潜能巨大。
第一,可以改善磨料的分散性。碱性抛光液中CeO2磨料带负电荷,加入阴离子表面活性剂可以增强其Zeta电位,增大磨料间静电斥力,实现抛光液稳定。此外,非离子型表面活性剂的结构中有聚合的长链,吸附在磨料表面可以形成较强的空间位阻,同样能增加不溶性磨料的悬浮稳定性。
第二,增强抛光液对工件的润湿性。通过降低表面张力,增强对工件表面的润湿,使抛光液与凹陷表面充分接触并发挥作用,提高抛光性能。
第三,减少工件表面的污染。抛光后工件表面会残留大量磨料和有机试剂,且吸附方式会慢慢从物理吸附转变为化学吸附,增大去除难度。合适的表面活性剂可优先于污染物吸附在工件表面,从源头减少污染,提高抛光洁净度。第四,降低腐蚀速率。在硅衬底的抛光中加入FA/O表面活性剂使得去除凸起部位过程中,对表面凹陷进行类似腐蚀抑制剂的缓蚀保护,避免过度腐蚀。
抛光液种类繁多,大多是根据客户的工艺进行定制化
根据研磨颗粒,大致分为二氧化硅抛光液、氧化铈抛光液、氧化铝抛光液和纳米金刚石抛光液。
• 二氧化硅抛光液:以高纯度硅粉为原料,经特殊工艺生产的一种高纯度低金属离子型抛光产品。广泛用于多种材料纳米级的高平坦化抛光。
• 氧化铈抛光液:稳定性能好,颗粒均匀,平均粒径100纳米,用于光学玻璃抛光。
• 氧化铝抛光液:氧化铝抛光液以分级后氧化铝微粉为原料,按特殊配方充分混合制备而成,用于各类工件粗抛、中抛、精抛工序。
• 纳米金刚石抛光液:由优质金刚石微粉、复合分散剂和分散介质组成,配方多样化,适用性强,广泛用于硬质材料的研磨和抛光。

来源:上海蔡康光学仪器有限公司
根据应用领域,大致分为硅抛光液、铜及铜阻挡层抛光液、钨抛光液、钴抛光液、层间介质层抛光液、浅槽隔离层抛光液和3D封装硅通孔抛光液。
• 硅抛光液:用于单晶硅/多晶硅的抛光,主要用于硅晶圆初步加工。
• 铜及铜阻挡层抛光液:芯片中铜及阻挡层的去除和平坦化。生产逻辑、存储芯片需大量使用。
• 钨抛光液:芯片中钨塞和钨通孔的平坦化。生产存储芯片需大量使用,逻辑芯片只用于部分工艺。
• 钴抛光液:用于10nm节点以下芯片中钴的去除和平坦。
• 介质层抛光液:用于集成电路制造工艺中层间电介质和金属间电介质的去除和平坦化
• 浅槽隔离层(STI)抛光液:用于集成电路制造工艺中浅槽隔离的抛光。
• 3D封装硅通孔(TSV)抛光液:用于对硅通孔(TSV)的抛光。

来源:东菀市创力半导体科技有限公司
参考来源:
[1] 雷红等,化学机械抛光(CMP)技术的发展、应用及存在问题
[2] 严嘉胜等,硅晶片化学机械抛光液的研究进展
[3] 何潮等,半导体材料CMP过程中磨料的研究进展
[4] 燕禾等,化学机械抛光技术研究现状及发展趋势
[5] 王东哲等,化学机械抛光液的研究现状
[6] 范永宇,CeO2复合磨料制备及其在化学机械抛光中的应用
[7] 中国科学院半导体研究所、芯小虎
[8] 上海蔡康光学仪器有限公司官网、东菀市创力半导体科技有限公司官网、吉致电子科技有限公司官网
(中国粉体网编辑整理/山林)
注:图片非商业用途,存在侵权告知删除!