中国粉体网讯 材料和设备是半导体产业的基石,是推动集成电路技术创新的引擎。半导体材料处于整个半导体产业链的上游环节,是半导体产业的基石和推动集成电路技术创新的引擎,对半导体产业发展起着重要支撑作用,与下游半导体市场的发展紧密相关。受益于半导体产业长期发展趋势,全球半导体材料市场规模保持增长态势,且制造更先进技术节点的逻辑芯片、3D存储芯片架构和异构集成技术需要更多的工艺步骤,带来更高的晶圆制造材料和封装材料消耗需求。根据TECHCET预测,2029年全球半导体材料市场规模将超过870亿美元,2024-2029年复合增长率为4.5%。
半导体材料市场产业规模大,根据SEMI,2024年全球半导体材料市场销售额增长3.8%,达到675亿美元,整体半导体市场的复苏,以及高性能计算和高带宽存储器制造对先进材料需求的增长,为全球半导体材料市场的营收增长提供了支撑。从材料大类来看,2024年全球晶圆制造材料和封装材料的销售额分别为429亿美元和246亿美元,占全球半导体材料销售额的比重分别约63.56%和36.44%;从地区分布来看,中国台湾和中国大陆仍是全球前两大半导体材料消费地区,中国台湾地区以201亿美元的营收,保持全球最大的半导体材料消费地区地位;中国大陆以135亿美元的营收继续保持同比增长,位居第二;韩国则以105亿美元的营收紧随其后,成为第三大消费地区。2024年,除日本外,所有地区均实现个位数增长。
在半导体特别是集成电路制造过程中,晶圆表面状态是影响晶圆优良率和器件质量与可靠性的最重要因素之一,化学机械抛光(CMP)等表面技术起到非常关键的作用。化学机械抛光技术被誉为是当今时代能实现集成电路(IC)制造中晶圆表面全局平坦化的唯一技术,化学机械抛光的效果直接影响到芯片最终的质量和成品率。
CMP主要工作原理是在一定压力下及抛光液的存在下,被抛光的晶圆对抛光垫做相对运动,借助纳米磨料的机械研磨作用与各类化学试剂的化学作用之间的高度有机结合,使被抛光的晶圆表面达到高度平坦化、低表面粗糙度和低缺陷的要求。
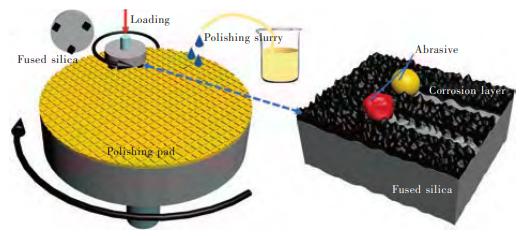
CMP工艺
根据不同工艺制程和技术节点的要求,每一片晶圆在生产过程中都会经历几道甚至几十道的CMP抛光工艺步骤。与传统的纯机械或纯化学的抛光方法不同,CMP工艺是通过表面化学作用和机械研磨的技术结合来实现晶圆表面微米/纳米级不同材料的去除,从而达到晶圆表面的高度(纳米级)平坦化效应。CMP已成为0.35μm以下制程不可或缺的平坦化工艺。
随着制程节点的进步,多层布线的数量及密度增加,CMP工艺步骤增加,CMP技术越来越重要,其对后续工艺良率的影响越来越大。例如14纳米技术节点的逻辑芯片制造工艺所要求的CMP工艺步骤数将由180纳米技术节点的10次增加到20次以上,而7纳米及以下技术节点的逻辑芯片制造工艺所要求的CMP工艺步骤数甚至超过30次。此外,更先进的逻辑芯片工艺可能会要求抛光新的材料,为抛光液带来了更多的增长机会。同样地,对于存储芯片,随着由2D NAND向3D NAND演进的技术变革,也会使CMP工艺步骤数近乎翻倍,带动了钨抛光液及其他抛光液需求的持续快速增长。此外,先进封装技术的应用使CMP从集成电路前道制造环节走向后道封装环节,在如硅通孔(TSV)、混合键合(Hybrid Bonding)等工艺中得到广泛应用。
化学机械抛光液在CMP技术中至关重要,在抛光材料中价值占比超过50%,其耗用量随着晶圆产量和CMP平坦化工艺步骤数增加而增加。根据应用的不同工艺环节,可以将抛光液分为硅衬底抛光液、铜及铜阻挡层抛光液、钨抛光液、介质材料抛光液、基于氧化铈磨料的抛光液以及用于先进封装的硅通孔(TSV)抛光液等。抛光液特点为种类繁多,即使是同一技术节点、同一工艺段,根据不同抛光对象、不同客户的工艺技术要求也有不同配方。
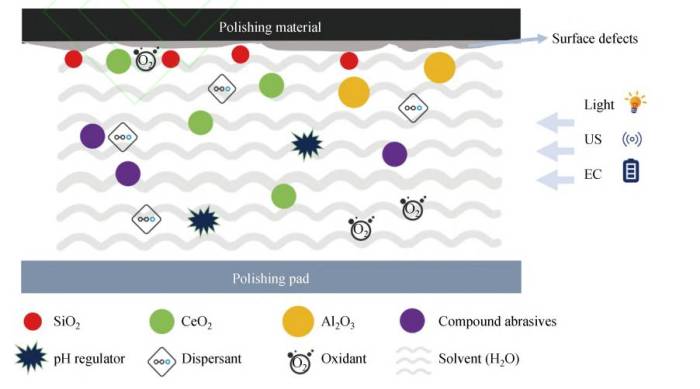
化学机械抛光液各组分
根据TECHCET,2024年全球半导体CMP抛光材料(包括抛光液和抛光垫,其中抛光液占比近60%)市场规模为34.2亿美元,2025年预计增长6%至36.2亿美元。随着全球晶圆产能的持续增长以及先进技术节点、新材料、新工艺的应用需要更多的CMP工艺步骤,TECHCET预计2029年全球半导体CMP抛光材料市场规模将超过50亿美元,2024-2029年复合增长率为8.6%。
参考来源:
[1]王东哲等,化学机械抛光液的研究现状
[2]何潮等,半导体材料CMP过程中磨料的研究进展
[3]燕禾等,化学机械抛光技术研究现状及发展趋势
[4]安集科技官网、巨潮资讯网、中国粉体网
(中国粉体网编辑整理/山林)
注:图片非商业用途,存在侵权告知删除!


















