中国粉体网讯 在科技日新月异的当下,芯片技术持续迭代升级,其中封装技术的创新对芯片性能的提升起着关键作用。2.5D封装技术作为前沿的封装方式备受瞩目,而玻璃通孔(TGV)技术更是为2.5D封装注入了新活力。接下来,让我们深入了解基于TGV技术的2.5D封装。
2.5D封装
传统的芯片封装方式主要是2D封装,即芯片在一个平面上进行布局和连接。随着技术的发展,这种封装方式在提高芯片集成度和性能方面逐渐遇到瓶颈。而2.5D封装则是在2D封装的基础上,引入了一个中介层,实现了芯片在一个近似三维的空间内进行连接和布局。简单来说,2.5D封装就是把多个芯片放置在一个中介层之上,通过中介层实现芯片之间以及芯片与外部电路的连接,有点像是在芯片们之间搭建了一座“立交桥”,让信号能够更高效地传输。
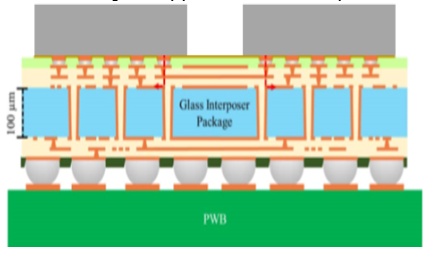
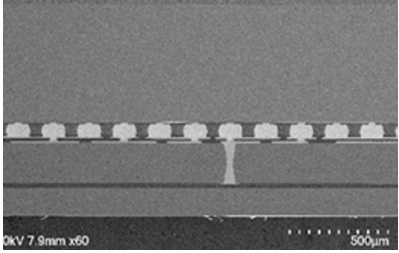
2.5D玻璃中介层 来源:云天半导体
TGV技术
TGV技术,简单来说,就是在玻璃基板上打造垂直的电气互连通道。其制作流程包含多个精细环节。首先,以高品质硼硅玻璃、石英玻璃等作为基础材料,接着通过种子层溅射,在玻璃表面覆盖一层薄薄的导电种子层;随后进行电镀填充,让金属(比如铜)填满预先设计好的孔道,形成导电通路;再利用化学机械平坦化工艺,使玻璃基板表面变得平整光滑,确保后续工艺的顺利开展;最后通过RDL再布线和bump工艺引出,成功实现3D互联。
TGV技术在2.5D封装中的独特作用
构建高效信号传输桥梁:在2.5D封装里,多个芯片被安置在中介层之上。当采用TGV技术时,玻璃中介层凭借其内部的TGV通孔,为芯片之间以及芯片与外部电路搭建起高效的连接通道。相比传统的2D封装,信号无需在平面上迂回传输,而是能够借助TGV实现近乎直线的快速传输,大大缩短了传输路径,进而显著提升信号传输速率,降低信号延迟。
实现超高密度集成:TGV技术能够在有限的玻璃基板空间内,打造出数量众多且间距极小的通孔,这一特性使得2.5D封装在单位面积上能够实现更高密度的芯片连接。以高端服务器芯片为例,借助TGV技术,多个处理器核心、大容量缓存芯片以及各类输入/输出(I/O)芯片得以紧凑地集成在一个封装内,极大地提升了芯片的整体集成度,让单个封装能够承载更多的功能,为构建强大的计算系统奠定了坚实基础。
技术优势显著
卓越的高频电学性能:玻璃材料属于绝缘体,其介电常数大约仅为硅材料的三分之一,损耗因子更是比硅材料低2-3个数量级。这一特性使得基于TGV技术的2.5D封装在高频信号传输时,衬底损耗和寄生效应大幅降低,能够出色地保证传输信号的完整性。在5G通信领域,信号频率极高,对信号传输的稳定性和准确性要求极为苛刻。采用TGV技术的2.5D封装能够完美契合这一需求,有效减少信号失真和干扰,保障5G通信的高速、稳定运行。
成本优势尽显:一方面,Corning、Asahi以及SCHOTT等玻璃厂商能够提供超大尺寸(超过2m×2m)和超薄(小于50µm)的面板玻璃以及超薄柔性玻璃材料,大尺寸超薄面板玻璃易于获取,且制作玻璃转接板时不需要沉积绝缘层,使得玻璃转接板的制作成本大约仅为硅基转接板的八分之一。另一方面,TGV技术的工艺流程相对简单,不需要在衬底表面及TGV内壁沉积绝缘层,在超薄转接板制作中也不需要减薄工序,进一步降低了生产成本。这使得基于TGV技术的2.5D封装在大规模应用时,能够有效控制成本,提高产品的市场竞争力。
出色的机械稳定性:即便玻璃转接板的厚度小于100µm,其翘曲程度依然较小。这种出色的机械稳定性为芯片封装提供了可靠的物理基础,确保在复杂的工作环境下,芯片之间的连接依然稳固,不会因基板的变形而影响性能,大大提高了封装的可靠性和耐用性。例如,厦门大学于大全团队将金刚石直接集成到芯片背面,并与玻璃基板进行异质集成构建了一个高效的散热系统。该研究采用纳米层Cu/Au重结晶的低温连接技术,将金刚石与硅芯片键合,并将此结构封装到玻璃基板上。玻璃基板作为中介层,其低热膨胀系数与硅芯片的良好匹配有效减少了热循环过程中产生的热应力。
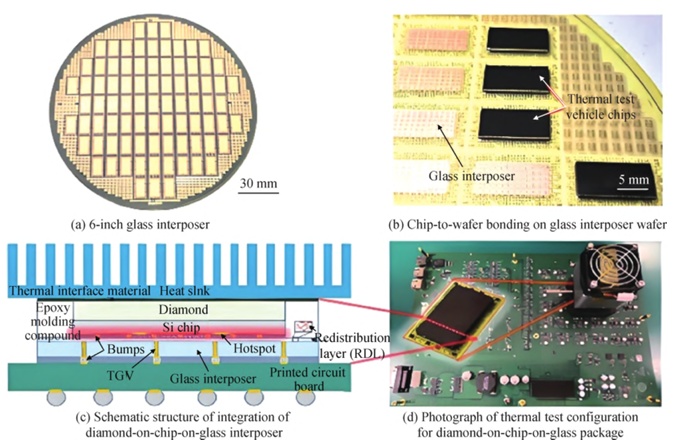
金刚石-芯片-玻璃中介层封装集成和热测试 来源:Zhong.Heterogeneous integration of diamond-on-chip-on-glass interposer for efficient thermal management.
参考来源:
云天半导体官网
马千里.2.5D封装关键技术的研究进展
Zhong.Heterogeneous integration of diamond-on-chip-on-glass interposer for efficient thermal management.
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!


















