中国粉体网讯 近年来,以第三代半导体材料为基础的新兴技术正迅速崛起,碳化硅由于具有宽带隙、低电阻、良好的导热性和导电性等一系列优点使其可以作为第三代半导体材料的代表成为全球半导体市场争夺的焦点,作为耐高温高频的器件广泛的应用于LED灯、集成电路和逆变器中。随着信息技术和科技的不断进步,市场上对碳化硅的表面平整度提出了更高的要求,工业要求最终的碳化硅晶圆表面光滑平整无缺陷,而传统的工艺如机械抛光和化学抛光,前者单纯利用简单的机械研磨,后者仅依靠腐蚀剂的化学反应,两者都会对晶圆表面造成损伤。目前,唯一能解决这个难题的就是将二者结合起来——化学机械抛光技术(CMP)。
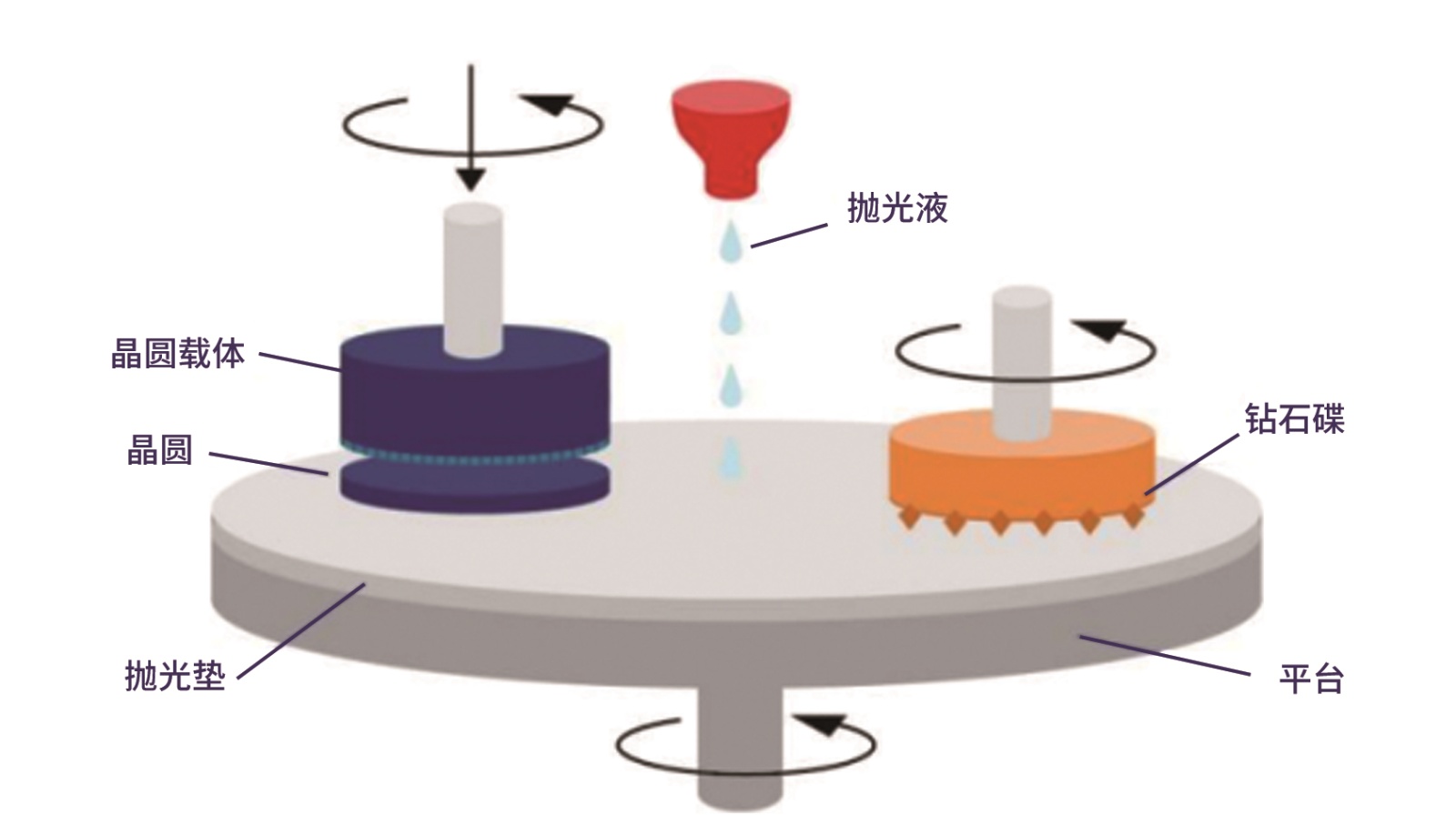
CMP工作原理
化学机械抛光技术是目前集成电路芯片全局平面化的最好方法。该技术将抛光液浆料的化学作用和浆料中磨粒的机械磨削作用紧密地结合在一起,整平抛光片表面,因此,抛光液是CMP技术中的关键因素。抛光液主要由磨料、溶剂和添加剂组成,其中磨料的种类、硬度、形貌、大小、粒度分布会影响到抛光质量的好坏,比如磨料的硬度过大、形貌不规则会引起CMP过程中机械作用的比重增大,坚硬的、形貌不规则的磨料与被抛光工件的表面接触,虽然会使得材料去除效率大幅度增加,但工件表面会出现较多的划伤、坑洼等不平坦现象,使得表面粗糙度较大。
目前市场上使用最为广泛的几种磨料是SiO2、CeO2、Al2O3。SiO2抛光液选择性、分散性好,机械磨损性能较好,化学性质活泼,并且后清洗过程处理较容易;缺点为在抛光过程中易产生凝胶,对硬底材料抛光速率低;CeO2抛光液的优点是抛光速率高,材料去除速率高,缺点是黏度大、易划伤,且选择性不好,后续清洗困难;Al2O3抛光液的缺点在于选择性低、分散稳定性不好、易团聚等,但对于硬底材料衬底等却具有优良的去除速率。随着LED、第三代半导体的发展,Al2O3在CMP中的应用显得更为重要。
前面我们说到磨料的形貌、大小、粒度分布等会影响到抛光质量的好坏,对研磨抛光所用的高纯氧化铝而言,利用不同制备方法所得的氧化铝性质也不尽相同。目前,水解法、溶胶凝胶法等液相法是制备高品质高纯氧化铝的常用方法,这些方法往往最终需要对中间产物进行高温煅烧,煅烧工艺对最终产品的性能同样有一些微妙的影响,并最终影响抛光效果。
9月27日,中国粉体网将在江苏·扬州举办2024全国高纯氧化铝粉体制备技术及应用交流大会。我们邀请到上海工程技术大学张泽芳副研究员出席本次大会并作题为《氧化铝的焙烧工艺对其CMP性能的影响》的报告。

(中国粉体网编辑整理/山川)
注:图片非商业用途,存在侵权告知删除























