中国粉体网讯 近日,国瓷材料举行了2022年度网上业绩说明会,在业绩会上国瓷材料总经理霍希云表示,精密陶瓷领域是国瓷材料未来新的增长引擎,公司已经掌握了陶瓷球、陶瓷基板等几种产品从粉体到精密结构件乃至模组的一系列核心技术和制备工艺,将来有望在半导体等方面快速实现进口替代。
在面对半导体先进封装的陶瓷TCV(Through Ceramic Via),涉及陶瓷粉料、陶瓷晶圆制备以及TCV技术,跨度大,技术难度高,但相对于硅TSV以及玻璃TGV,陶瓷TCV有明显的机械和电学性能优势,国瓷材料结合自身技术沉淀以及陶瓷金属化技术基础,已完成技术可行性研究,且已在部分高难度单点工艺取得突破,正在和下游特定伙伴进行深度配合和产品验证。
什么是陶瓷TCV?
陶瓷穿孔互连技术(TCV),是一种应用于高密度三维封装的新型互连技术。其利用陶瓷穿孔实现电路与电路之间、电路与附加单元之间线路垂直导通,利用薄膜多层电路实现多层布线,使电路体积在三维方向得到延伸,达到结构密度最大化。
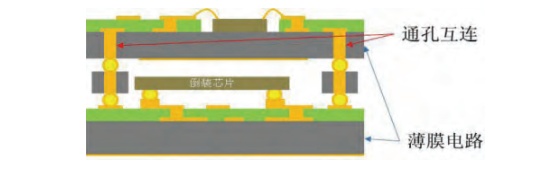
TCV概念图
先进封装正在成为半导体产品性能提升的必由之路,也成为推动国内集成电路产业集聚发展的重要动力。三维集成微系统,也被认为是下一代集成电路发展的主要形式,其中转接板作为三维集成的核心材料,有专家预测预计到2025年市场规模可达130亿美元。
转接板类型和技术有哪些?
转接板作为多种元器件组装平台,是封装体的基础,一定程度上决定了系统的性能优劣。在电子封装领域,基板通常需要具备高电阻率、耐高温、高导热率、耐腐蚀和低成本等性能。
按照基板材料的不同,转接板可大致分为有机、硅基、玻璃和陶瓷四种。
(1)有机转接板。有机转接板的基板材料通常以玻璃纤维作加强剂有机树脂为基础材料,采用层压加工工艺即可进行大规模有机转接板制造。与其他转接板相比,有机转接板的优势在于其成本低,工艺简单且成熟,又因为其粗糙度较小,
所以通孔金属化难度较小。
但是,有机转接基板的热性能较差,其热膨胀与硅组件相差较大,成品率低,随着层数的增加有机转接板出现明显的翘曲,一定程度上限制高集成三维封装领域中有机转接板的应用。
(2)硅基转接板。硅基转接板是一种已在工业生产中应用广泛的转接板技术,是通过硅通孔技术(TSV)实现基板上、下表面的垂直互连。然后,硅作为具有一定导电性的半导体材料,在电子系统中存在通孔漏电流及信号的耦合与串扰,且该情况在高频电路中尤为严峻。因此在一定程度上限制了基于TSV转接板封装的器件性能。
(3)玻璃转接板。玻璃转接板采用玻璃通孔技术(TGV)可以在一定程度上克服由于硅半导体特性带来的缺点。通常所用玻璃的主要成分为SiO2,电阻率较高(1012-1016Ω·cm),信号隔离度较好,且高温下性能稳定。然而玻璃转接板因其基板脆度较大,在基板通孔加工过程中难度较大,成品率较低,成本较高,同时在加工过程过存在的细微缺陷会导致通孔漏电流的形成。
(4)陶瓷转接板。陶瓷转接板就是利用陶瓷TCV技术,基于陶瓷材料的良好绝缘性能和机械性能,在转接板封装技术中存在较大的优势。
陶瓷转接板中所用到陶瓷材料有哪些?
通常陶瓷材料有AlN、Al2O3和BeO等,以下对陶瓷材料的热性能、机械性能及电性能进行对比。
a . 热性能
AlN陶瓷因其具有与Si相近的低热膨胀系数,电阻率高,同时其热导率远远高于其他陶瓷材料,因此芯片与芯片间、基板上下表面间的信号损耗较小,信号完整性良好。
AlN、SiO2 和Si性能参数对比
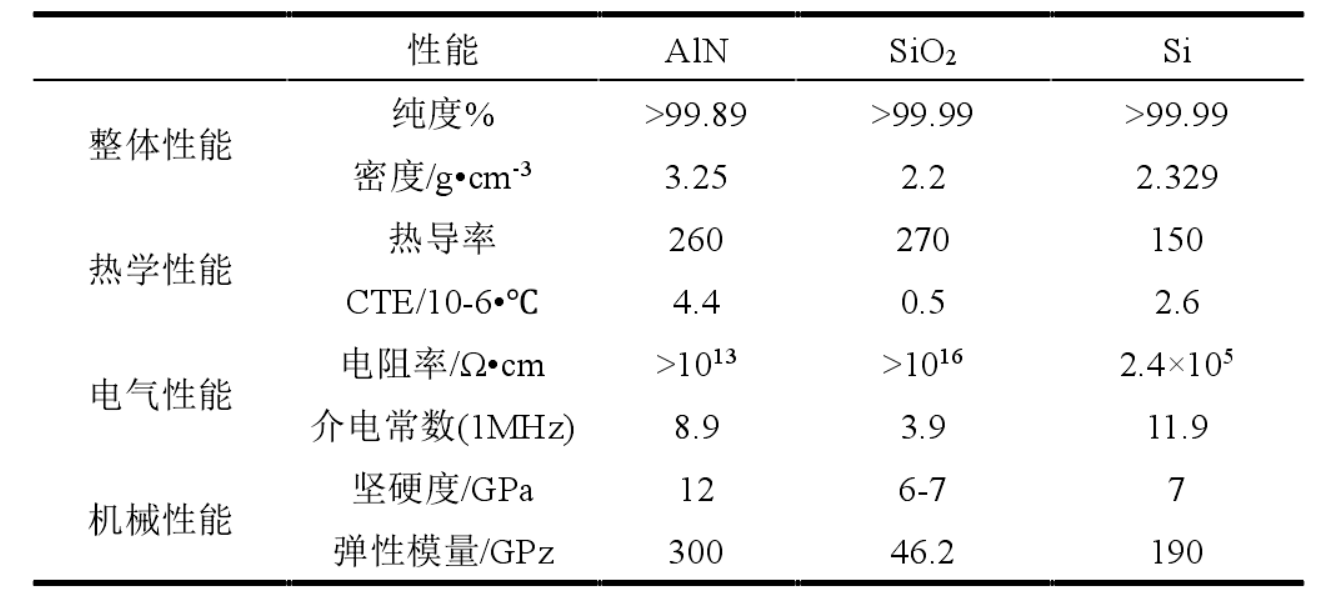
SiC制备成本较高,因此考虑AlN材料作为陶瓷转接板基板材料。
b .陶瓷材料的机械性能
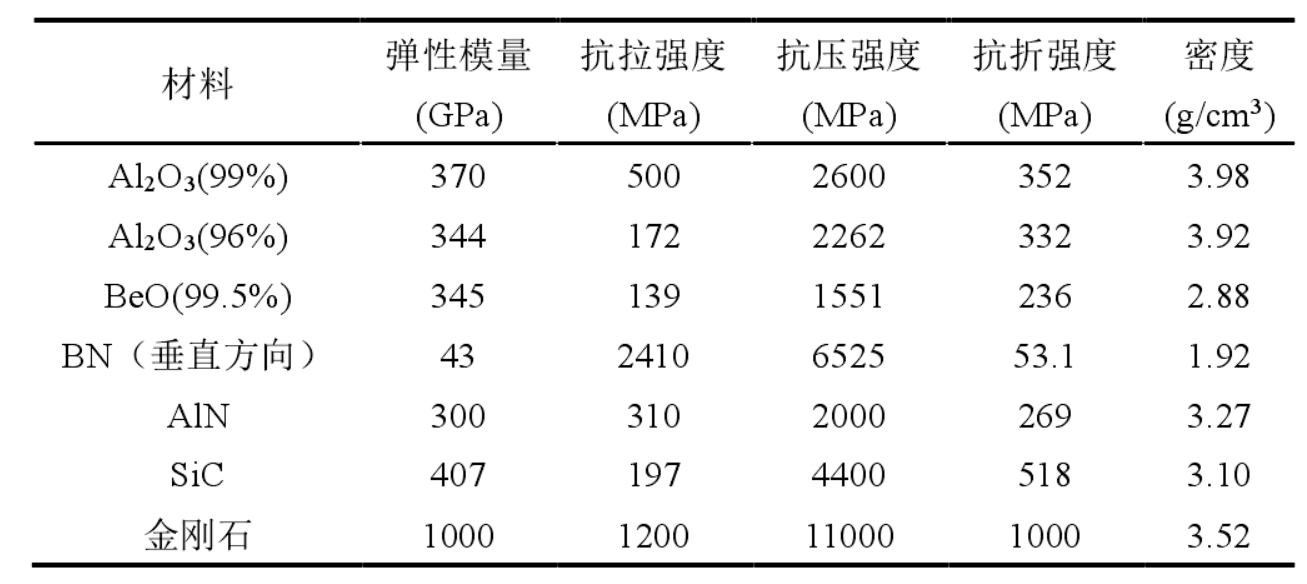
部分陶瓷材料机械性能
综合以上五项机械性能相比,陶瓷转接板的机械性能均优于硅基转接板和玻璃转接板,且在多种陶瓷材料中,Al2O3(99%)与AlN机械性能优良,成本较SiC、金刚石低,制备过程相对容易。在机械性能方面更适用于三维封装体内转接板的基底制作。
c.陶瓷材料电性能
电子终端市场的发展趋向于小型化、高度集成化、多种功能化等,电性能的优劣直接决定了产品内电子电路的工作质量以及电路对电磁的抗干扰能力。
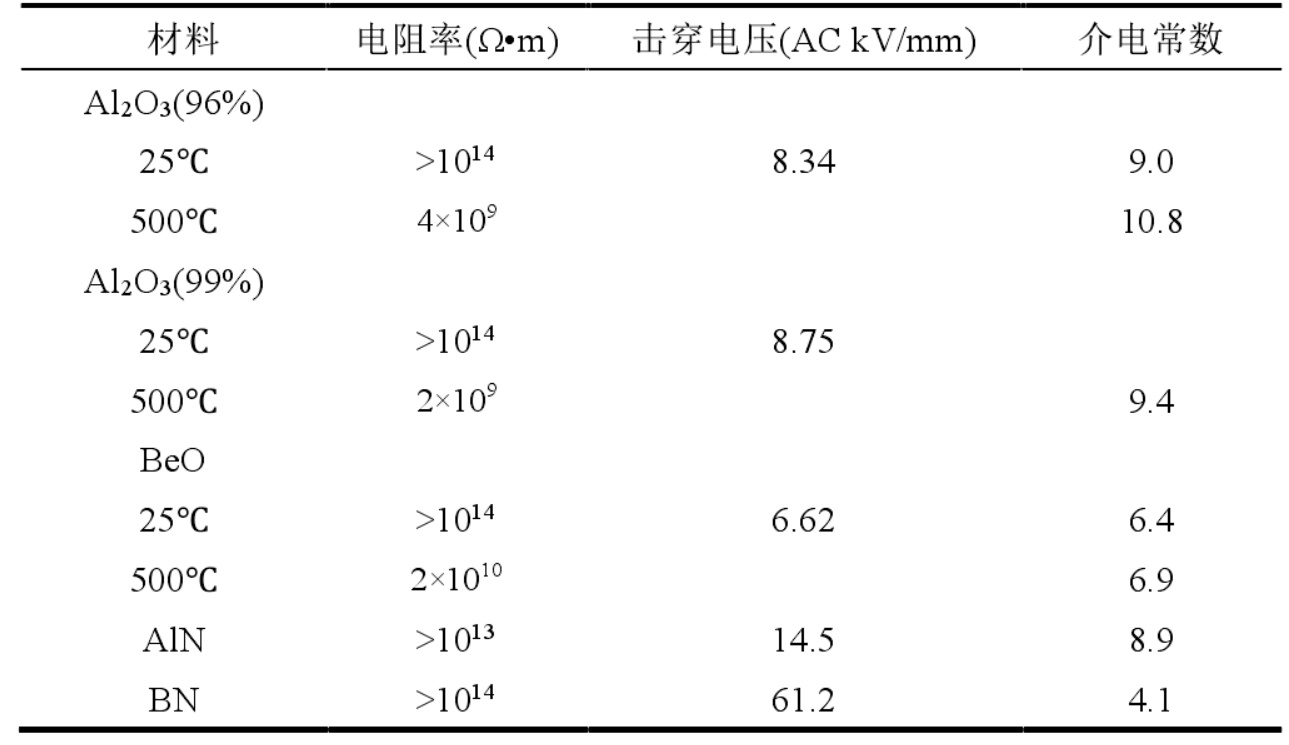
部分陶瓷材料电性能
纯度99%的Al2O3材料在25℃工作环境中电阻率较高,随温度升高,电阻率有所降低。BeO各项指标良好,但具有轻微毒性,不考虑BeO材料作陶瓷转接板;AlN材料的电阻率在不同温度下电性能保持稳定,电阻率较高,且击穿电压居中,介电常数较高。
综合以上因素,AlN材料硬度高,机械强度大,牢固性好。综合考量电学、热学和机械等方面的性能指标,基于AlN材料的TCV转接板性能较为优良,具有良好的发展前景。
陶瓷TCV技术在国内处于起步阶段,在材料体系中,除了陶瓷基板的堆叠,还可以开发玻璃、蓝宝石等多种基板的异构堆叠,为微系统的多功能异构集成的微型化集成提供更多更有效的解决途径。
来源:
孙雅婷:陶瓷转接板关键技术
秦跃利等:陶瓷穿孔三维互连(TCV)技术研究
全景网、中国粉体网
(中国粉体网编辑整理/空青)
注:图片非商业用途,存在侵权告知删除


















