中国粉体网讯 电子封装技术发展的同时也伴随着电子封装材料和工艺的发展,目前常用封装材料的主要材料有塑料、金属和陶瓷,目前来说塑料基片还占据主导位置,但它的散热及稳定性能较差,被新的材料取代是早晚的事,陶瓷封装材料虽不是主要材料,但它综合性能最好,且在电子封装领域的应用占比也在逐年增加。
电子封装对材料的要求
陶瓷材料在电子封装中主要用作基板,且对这种陶瓷基板有非常严格的性能要求。
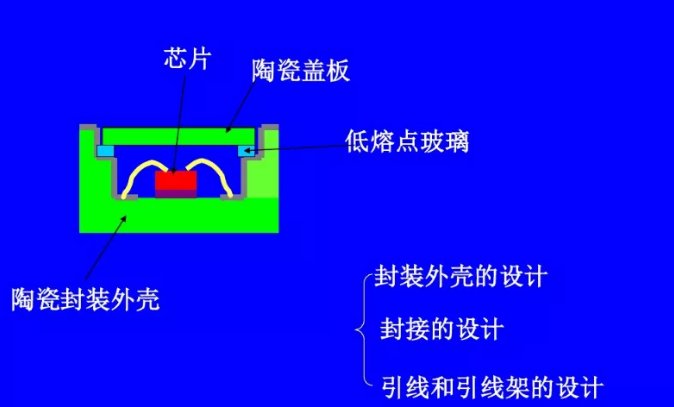
(图片来源于网络)
1、在电性能方面,要求有较低的介电常数、低介电损耗、高绝缘电阻、以及高温稳定性。
2、在热性能方面,要求高热导率、良好散热性、热膨胀系数与待装配器件匹配,以及优秀的耐热性能。
3、在机械性能方面,要求机械强度高、良好的可加工性能、适合精细化和多层化制作工艺,以及表面光滑、变形小、无弯曲和无微裂纹等。
4、在其他方面,要求化学稳定性好、无害、成本低廉等。
氧化铝陶瓷是一种以a-Al2O3为主晶相的陶瓷材料,由于其本身具有高熔点、高硬度、耐热、耐腐蚀、电绝缘等特性,早就被研究并应用到电子封装领域了,尤其是球形氧化铝陶瓷,具备更优异的性能优势。
为啥要选球形氧化铝
我们都知道,陶瓷材料的性能和原料粉体颗粒的形貌和尺寸有很大关系,球形氧化铝尤其是超细球形氧化铝粉体,具有规则的形貌、较大的堆积密度、较好的流动性和较高的硬度和强度,能够制备出性能优异的基板。
氧化铝基板分类
1、HTCC
HTCC又称为高温共烧多层陶瓷基板。制备过程中先将球形氧化铝粉中加入有机黏结剂,混合均匀后成为膏状浆料,接着利用刮刀将浆料刮成片状,再通过干燥工艺使片状浆料形成生坯。然后依据各层的设计钻导通孔,采用丝网印刷金属浆料进行布线和填孔,最后将各生坯层叠加,置于高温炉(1600℃)中烧结而成。因为烧结温度高,导致金属导体材料的选择受限(主要为熔点较高但导电性较差的钨、钼、锰等金属),制作成本高。
2、LTCC
LTCC又称低温共烧陶瓷基板,其制备工艺与HTCC类似,只是在氧化铝粉中混入质量分数30%~50%的低熔点玻璃料,使烧结温度降低至850~900℃,因此可以采用导电率较好的金、银作为电极和布线材料。但另一方面,因为LTCC陶瓷料中含有玻璃相,其综合热导率仅为2~3W/(m·℃)。此外,由于LTCC采用丝网印刷技术制作金属线路,有可能因张网问题造成对位误差,而且多层陶瓷叠压烧结时还存在收缩比例差异问题,影响成品率。为了提高LTCC导热性能,可在贴片区增加导热孔或导电孔,但成本增加。

(图片来源于网络)
3、TFC
TFC即厚膜陶瓷基板,为一种后烧陶瓷基板。采用丝网印刷技术将金属浆料涂覆在陶瓷基片表面,经过干燥、高温烧结(700~800℃)后制备。金属浆料一般由金属粉末(Ag-Pd或Ag-Pt)、有机树脂和玻璃粉等组成。经高温烧结,树脂粘合剂被燃烧掉,剩下的几乎都是纯金属,由于玻璃质粘合作用在陶瓷基板表面。烧结后的金属层厚度为10~20μm,最小线宽为0.3mm。由于技术成熟,工艺简单,成本较低,TFC在对图形精度要求不高的电子封装中得到一定应用。
4、DBC
DBC又称直接键合铜陶瓷基板,由Al2O3陶瓷基片与铜箔在高温下(1065℃)共晶烧结而成,最后根据布线要求,以刻蚀方式形成线路。由于铜箔具有良好的导电、导热能力,而氧化铝能有效控制Cu-Al2O3-Cu复合体的膨胀,使DBC基板具有近似氧化铝的热膨胀系数,因此,DBC具有导热性好、绝缘性强、可靠性高等优点。
在封装领域的应用
1、IGBT封装
IGBT(绝缘栅双极晶体管)有输入阻抗高、开关速度快、通态电压低、阻断电压高、承受电流大等特点,成为当今功率半导体器件发展主流。其应用小到变频空调、静音冰箱、洗衣机、电磁炉、微波炉等家用电器,大到电力机车牵引系统等。目前国际IGBT市场主要由欧美、日本企业所垄断,但国内从2012年开始实现量产。
2、LD封装
LD封装是指通过电连接、光耦合、温控、机械固定及密封等措施使半导体LD成为具有一定功能且性能稳定的组件的装配过程。为提高LD器件可靠性,主要从两个方面选择热沉材料,一是材料热导率要高,二是材料与芯片间的热膨胀系数尽可能匹配。因此,氧化铝及氮化铝等陶瓷材料成为首选。
3、LED封装
由于氧化铝陶瓷具有的高绝缘、高导热和耐热、低膨胀等特性,特别是采用通孔互联技术,可有效满足LED倒装、共晶、COB(板上芯片)、CSP(芯片规模封装)、WLP(圆片封装)封装需求,适合中高功率LED封装。
4、光伏(PV)模组封装
光伏发电是根据光生伏特效应原理,利用太阳能电池将太阳光直接转化为电能。在聚焦型光伏(CPV)组件制造过程中,由于聚焦作用导致太阳光密度增加,芯片温度升高,必须采用陶瓷基板强化散热。实际应用中,陶瓷基板表面的金属层通过热界面材料(TIM)分别与芯片和热沉连接,热量通过陶瓷基板快速传导到金属热沉上,有效提高了系统光电转换效率与可靠性。
5、其它领域电子封装
许多行业(包括航天航空、地下钻探、汽车电子等)都需要能够在极端环境(如高温、高湿、高压力、多灰尘等)下可靠工作的电子器件。通常工程师会采用主动冷却技术,但某些应用可能无法进行冷却,或者电子器件在高温下工作时更为有利。因此,封装材料必须具有高耐热性和抗湿性,包括基板材料,热界面材料和焊线材料等。
参考来源
[1]程浩等.功率电子封装用陶瓷基板技术与应用进展
[2]龙乐.低温共烧陶瓷基板及其封装应用
[3]辛国锋等.大功率半导体激光器阵列的封装技术
[4]刘洁.超细球形氧化铝的制备及其粒度与晶型的控制
(中国粉体网编辑整理/山川)
注:图片非商业用途,存在侵权告知删除























