中国粉体网讯 随着集成电路产业的飞速发展,电子系统集成度的提高将导致功率密度升高,以及电子元件和系统整体工作产生的热量增加,有效的电子封装必须解决电子系统的散热问题。
陶瓷基板具有绝缘性能好、强度高、热膨胀系数小、优异的化学稳定性和导热性能脱颖而出,是符合当下高功率器件设备所需的性能要求。陶瓷基板按照工艺主要分为DPC、DBC、AMB、LTCC、HTCC等基板。目前在高功率器件以及IGBT模组的使用场景中散热基板目前主要以DBC、DPC、AMB三种金属化技术为主。
然而,随着电子器件向高功率密度和小型化发展,对高导热、高性能的陶瓷基板需求不断增涨,对陶瓷基板提出更高的要求。陶瓷衬底变薄是降低热阻的方法,但可靠性受损一直是薄陶瓷的一个问题,康宁公司凭借170多年的创新历史和世界一流的材料专业知识,开发了一种新颖的快速烧结工艺,可以形成连续烧结的薄陶瓷,薄而强,可以卷成卷(R2R)连续制造工艺。
这是首次以长度超过几米的R2R形式提供薄而灵活的陶瓷基板。采用快速烧结速度实现更高的吞吐量,从而降低成本。以R2R形式进行器件加工,从而提高制造生产率,减少能源使用,并提高产品质量。更重要的是,带状陶瓷是一种更加“绿色”的工艺,其能源使用效率高。

氧化铝带状陶瓷是一种薄而灵活的基材,与市售的薄陶瓷片相比,具有更光滑的天然表面和更少的缺陷。氧化铝带状陶瓷可有效导热,即使在高温下也是一种出色的电绝缘体。其特点如下:
(1)陶瓷基板衬底厚度可低至40微米,宽度可达100毫米,这种独特的格式允许缎带弯曲并被层压到弯曲的表面。
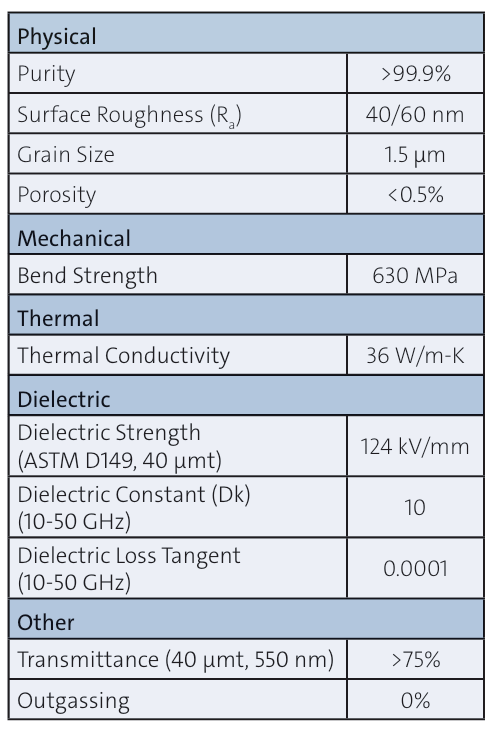
(2)具有高散热性和抗热震性,氧化铝带陶瓷具有低热阻,散热类似于250µm厚的氮化铝。
(3)极低而稳定的介质损耗。
(4)表面光滑,边缘干净。
康宁公司成立于1851年,是特殊玻璃和陶瓷材料的厂商,公司通过其在玻璃科学、陶瓷科学和光学物理领域的专业知识,开发众多改变行业和人类生活的产品。目前康宁公司的业务涵盖光通信、移动消费电子、显示科技、汽车应用、生命科学等五大市场。
随着激光、LED、IGBT、SiC等芯片功率的不断增加,散热问题已经变得不容忽视。陶瓷基板因其出色的导热性、绝缘性以及低热膨胀系数而广泛用于封装这些高功率芯片。根据Maxmize Market Research的报告,到了2021年,全球陶瓷基板市场规模已达到65.9亿美元,并预计到2029年,市场规模将达到109.6亿美元,年均增长率约为6.57%。随着半导体和新能源行业的发展,产业界对大功率电力电子芯片、光芯片等封装散热提出更高要求,陶瓷基板发展空间巨大。
来源:洞见热管理、康宁公司官网
(中国粉体网编辑整理/空青)
注:图片非商业用途,存在侵权告知删除


















