中国粉体网讯 除玻璃通孔成孔技术外,高质量的金属填充是限制玻璃基板应用的另一大技术难点。其一,因刻蚀工艺的影响,玻璃通孔技术(TGV)与硅通孔技术(TSV)存在差异,TGV孔径较大且多为通孔,其孔的形状主要有盲孔、垂直通孔、X型通孔和V型通孔四种类型,这给铜的沉积带来极大挑战,容易导致孔出现“堵塞”情况;其二,相较于硅材料,玻璃表面光滑,与常用金属的粘附性欠佳,这使得玻璃衬底与金属层之间极易发生分层,进而出现金属层卷曲甚至脱落的问题。
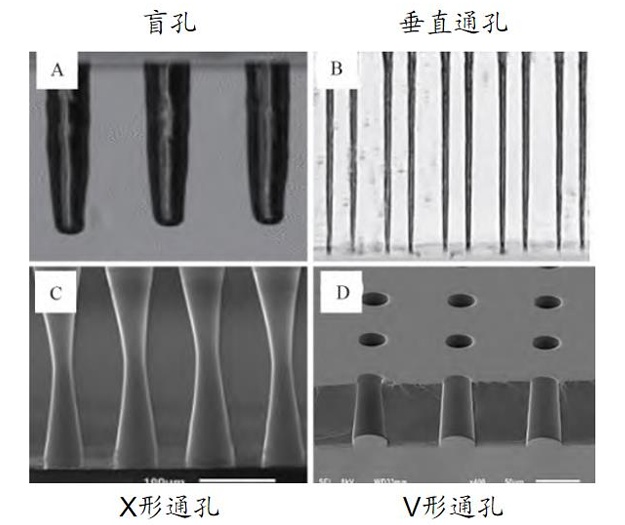
来源:《玻璃通孔三维互连镀铜填充技术发展现状》(纪执敬等)
目前,金属填孔TGV主要有两种工艺:一是铜浆塞孔工艺,包括“自下而上填充”、“蝶形填充”和“共形填充”三种填充方式,二是电镀工艺。这两种工艺在应用场景、材料成本和性能上存在差异。选择何种工艺取决于孔径、深宽比以及对电阻率和电导率的要求。
自下而上填充
目前,对于TGV盲孔的主要填充方式是自上而下的填充。通过在TGV孔口侧壁及表面添加抑制剂,在盲孔底部添加加速剂的方式,抑制TGV孔口侧壁及表面铜沉积速度的同时,加速盲孔底部的铜沉积,从而让铜形成一种自下而上的填充方式来确保整个盲孔的填充过程中没有孔洞和缝隙的出现。

自上而下填充过程示意图 来源:广发证券
蝶形填充
通孔与盲孔填充相比,二者存在显著差异,盲孔填充时,镀液在孔内流动性差,相对的,镀液可在通孔内部流动,极大地增强了通孔内的传质效果。此外,二者几何形状不同,通孔没有盲孔那样明确的底部,无法实现自下而上的填充方式。
目前,垂直TGV通孔通常采用蝶形填充的电镀方式。在TGV通孔壁上按照“两边多,中间少”的原则涂抹抑制剂,通过改变通孔内次级电流分布,促使铜优先在孔的中心沉积,从而形成形似“蝴蝶”的填充形貌,这也是该填充方式名称的由来,待通孔内形成蝴蝶形状后,通孔便转变为两个对称的盲孔,此时填充方式由蝶形填充切换为自上而下填充,最终实现对通孔的完整填充。
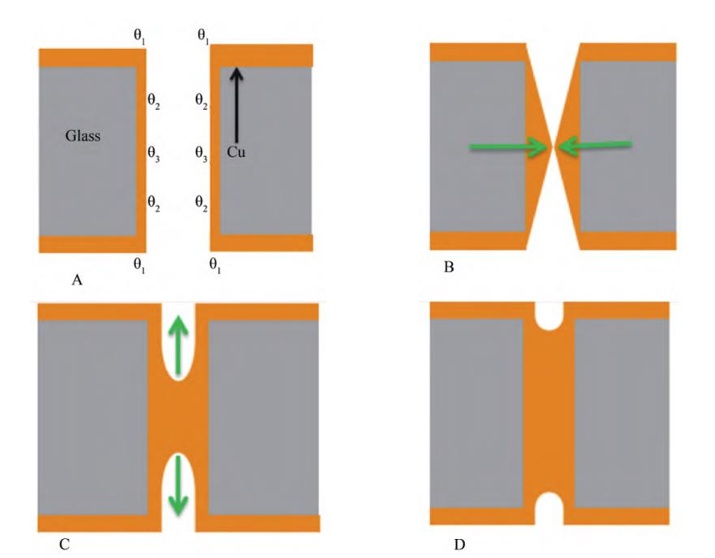
蝶形填充过程示意图 来源:广发证券
共形填充
共形填充是通过添加剂的作用使得TGV孔内铜的沉积速率与孔的侧壁以及表面的沉积速率相当的一种电镀方式。对于垂直的盲孔与通孔,共形填充模式下随着填充过程的进行,其深宽比不断增大,在填充的最后阶段容易出现孔洞缺陷,而X形、V形通孔由于其自身特殊孔形的原因,从根本上避免了中央孔洞缺陷的形成,例如,X形通孔的中间区域较窄,在两侧铜等速沉积的情况下会先于通孔中央形成连接,然后逐步向上下两个方向进行类似自上而下的填充。相比于垂直通孔的蝶形填充电镀模式,共形填充的电镀模式由于加速剂的使用以及TGV孔形的原因,可以实现更大电流密度下通孔的完整快速填充。
TGV孔内电镀薄层
除了以上三种TGV通孔填实工艺,TGV也可采用通孔内电镀薄层方案实现电学连接。将TGV基板浸入含有金属离子的电镀液中,通过外部电源在基板和电镀液之间施加电场。在电场作用下,金属离子向TGV孔内的阴极(玻璃基板表面)迁移,并在表面得到电子,还原沉积为金属原子,逐层堆积形成连续、均匀的金属薄层。通常电镀填孔需要现在玻璃通孔壁上沉积金属粘附层如钛(Ti)、铬(Cr)等种子层,然后再进行铜电镀,否则会出现脱落等现象。
参考来源:
纪执敬.玻璃通孔三维互连镀铜填充技术发展现状
陈力.玻璃通孔技术研究进展
(中国粉体网编辑整理/月明)
注:图片非商业用途,存在侵权告知删除!

















