中国粉体网讯 半导体和新材料方面的检测处于检测分析行业金字塔的最顶端。随着国内半导体与材料技术和科学的发展,对杂质和缺陷的分析检测方法在准确性和精度方面的要求越来越高。检测的内容也发生了变化,从材料缺陷宏观观察和电学性质的宏观测量转移到对表面、界面及薄膜的组份、结构和特征参数的细微研究。从对杂质和缺陷宏观效果评价发展到对他们电子结构及相互作用的探索。越来越多的新仪器、新技术、新方法被应用到新材料与半导体分析检测之中。
在第九届中国纳博会同期召开的“首届纳博会分析测试应用研讨会”上,国际领先的分析仪器纷纷亮相,他们依托科研人员独创性的分析方法与对仪器、产品、材料及工艺的深刻理解,为工业界解决实际生产过程中迫在眉睫的问题,进行了技术和案例的分享与研讨。粉体网小编在研讨会现场为大家直播牛津仪器、日立等仪器供应商的部分精彩报告内容。



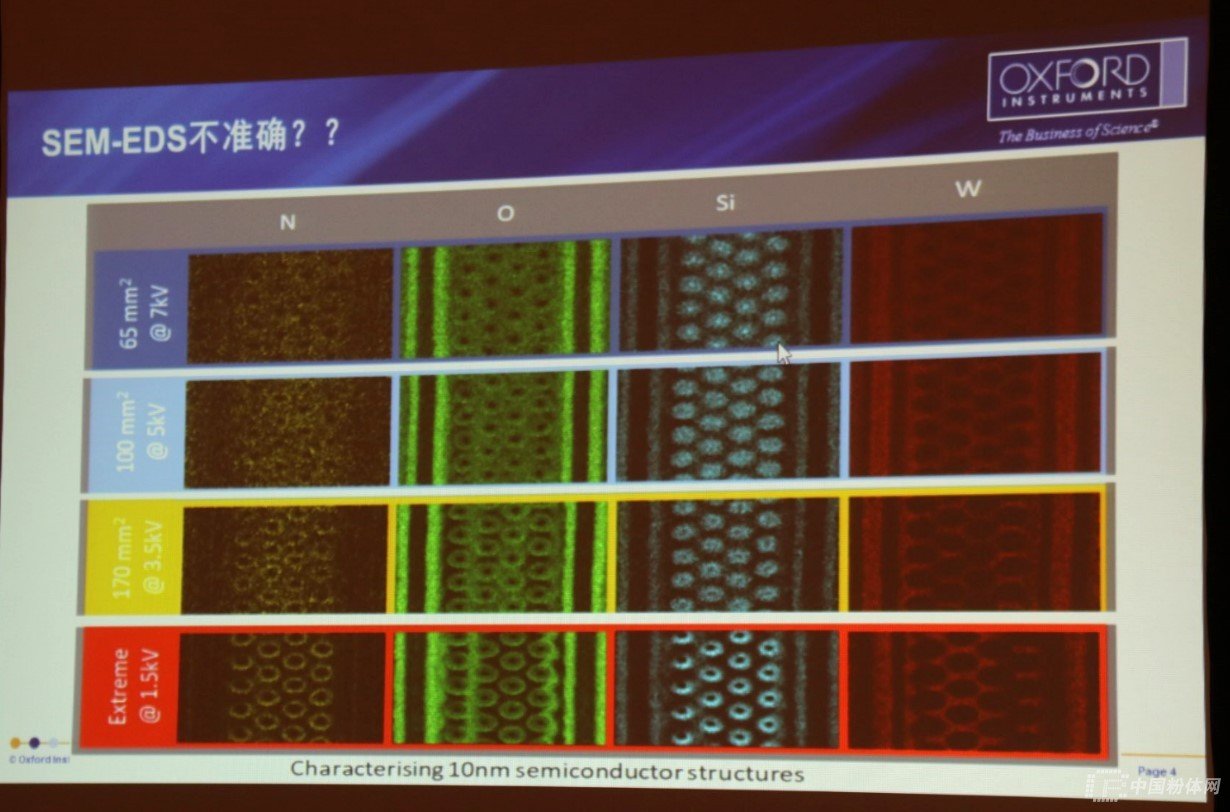



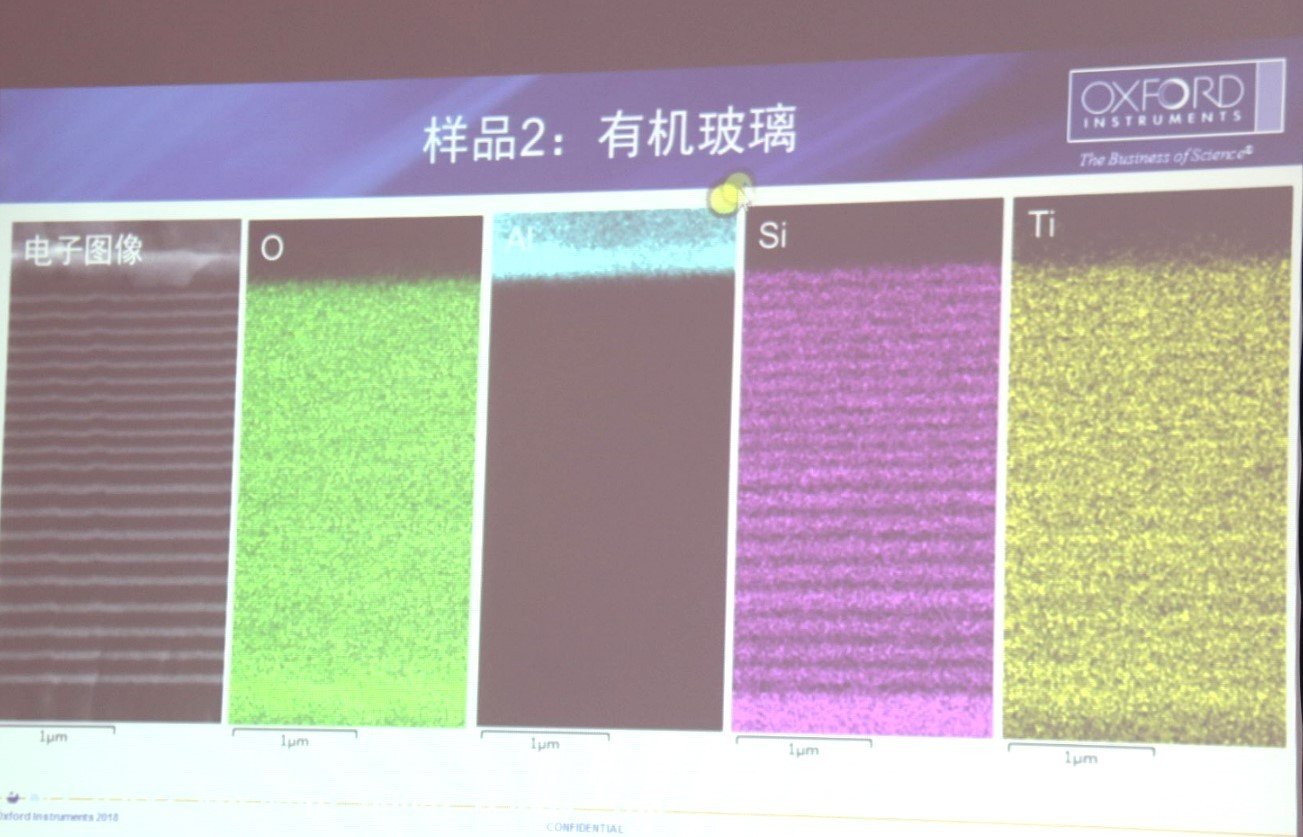


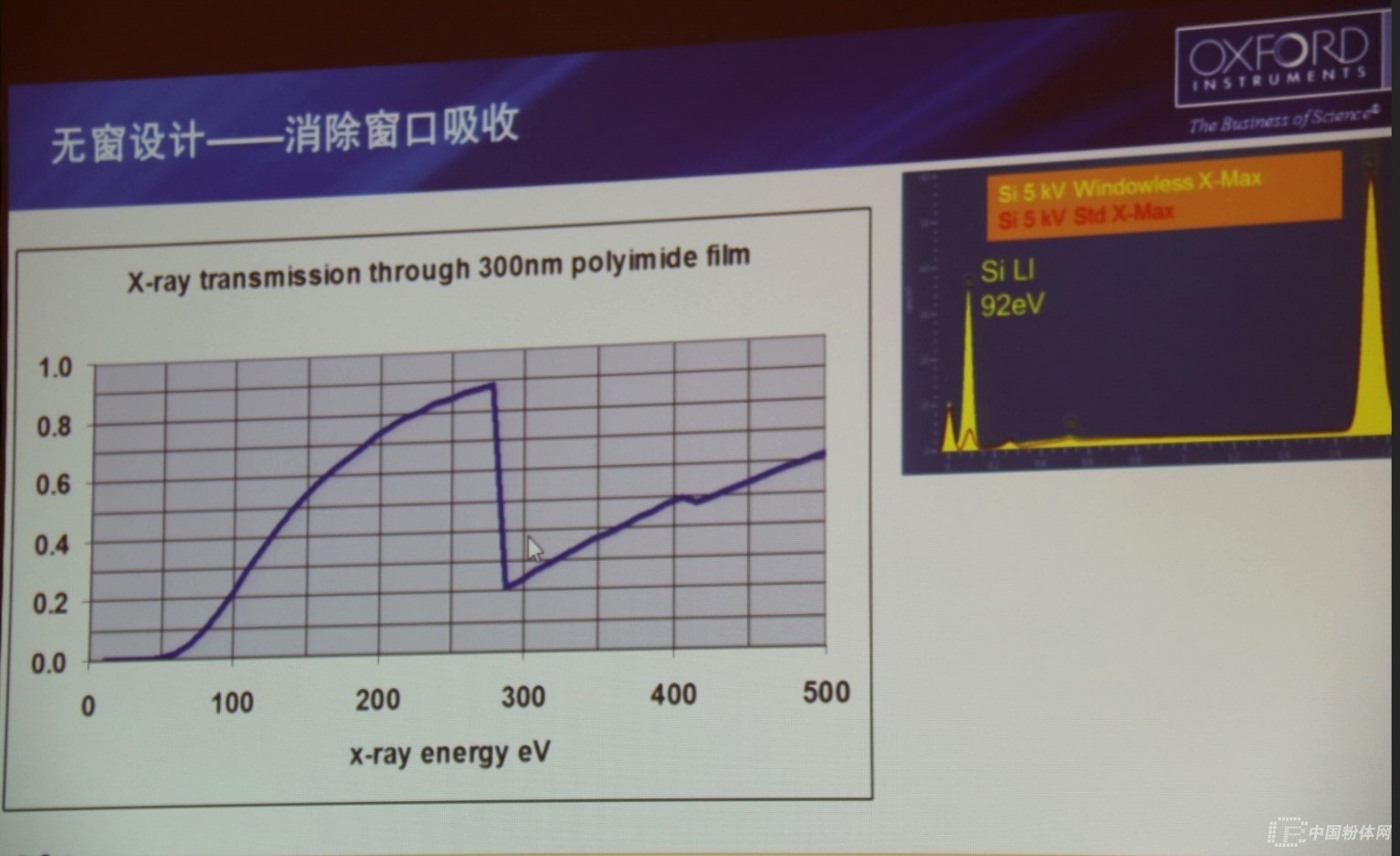
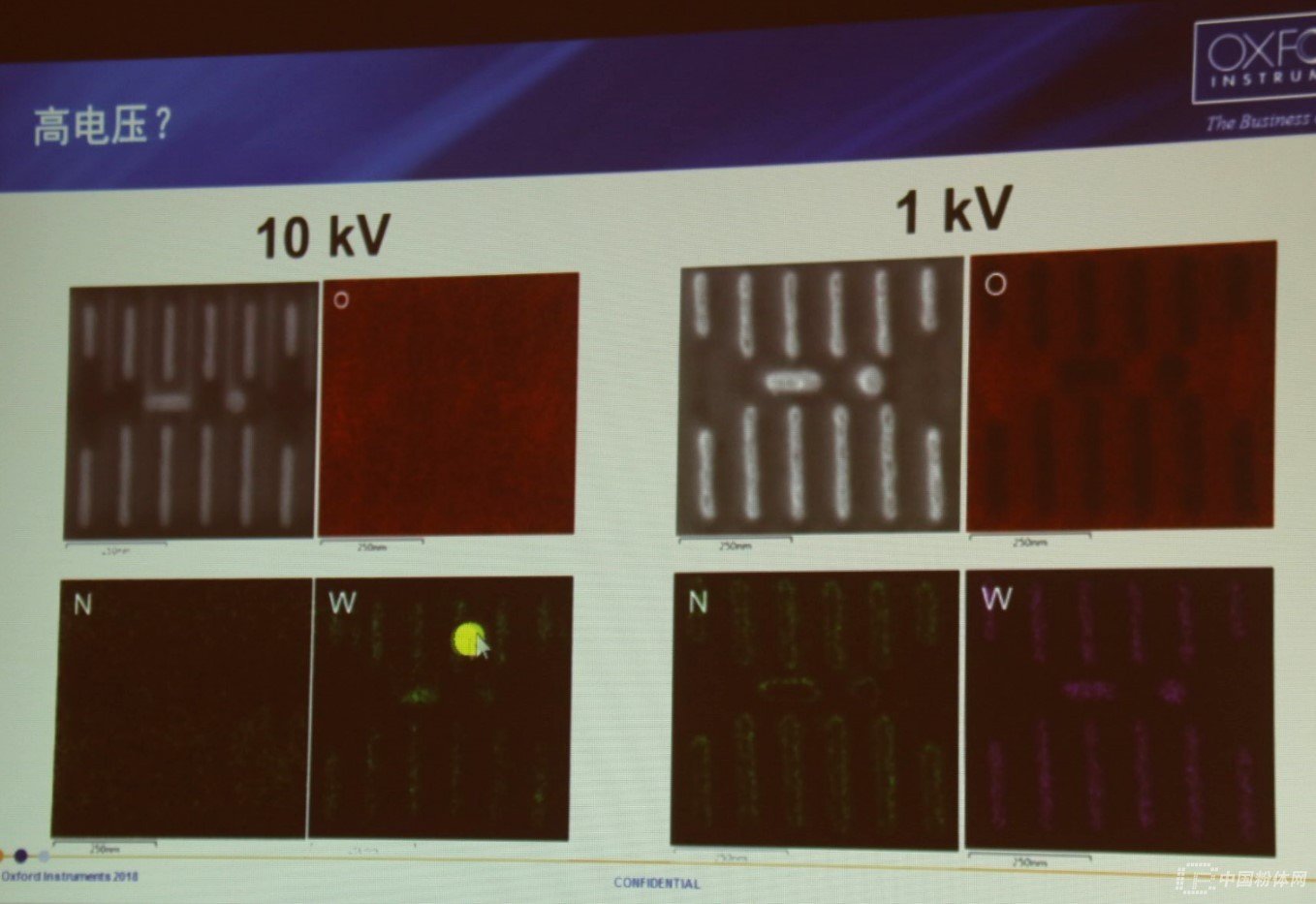
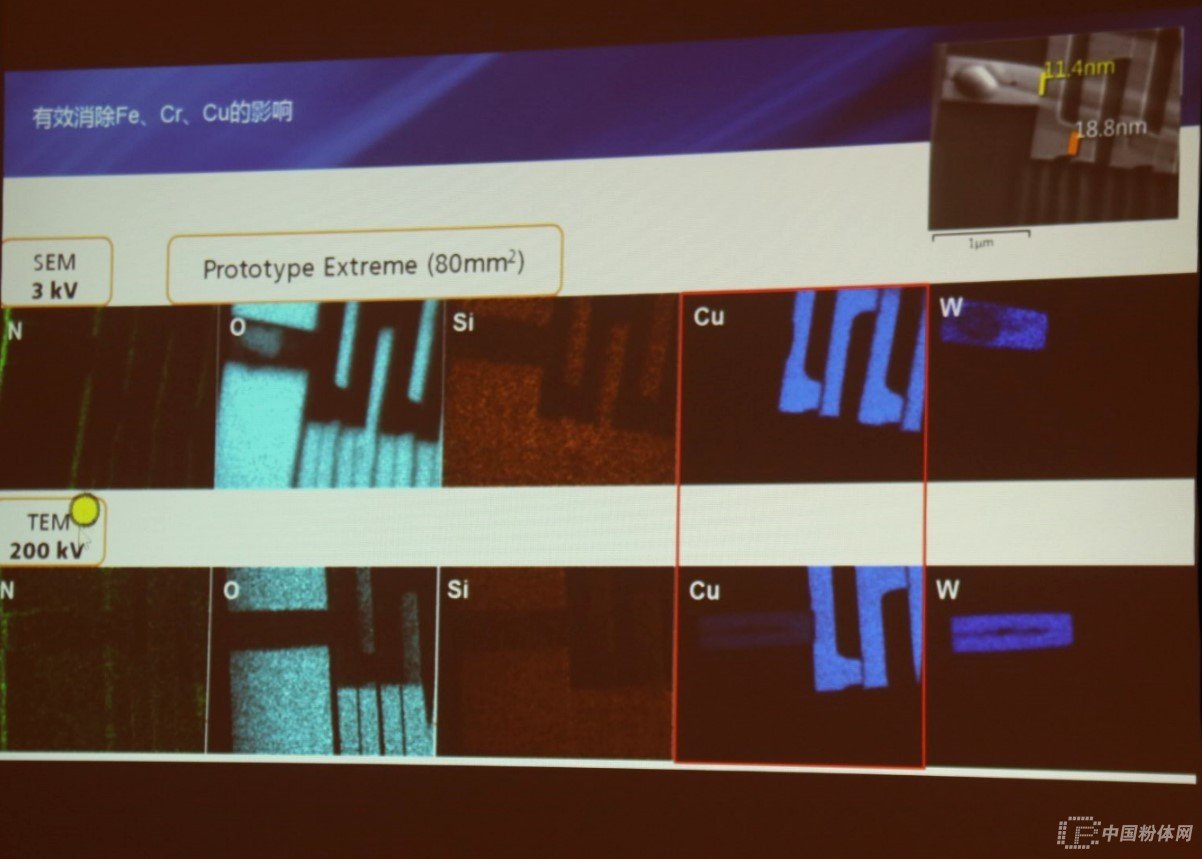



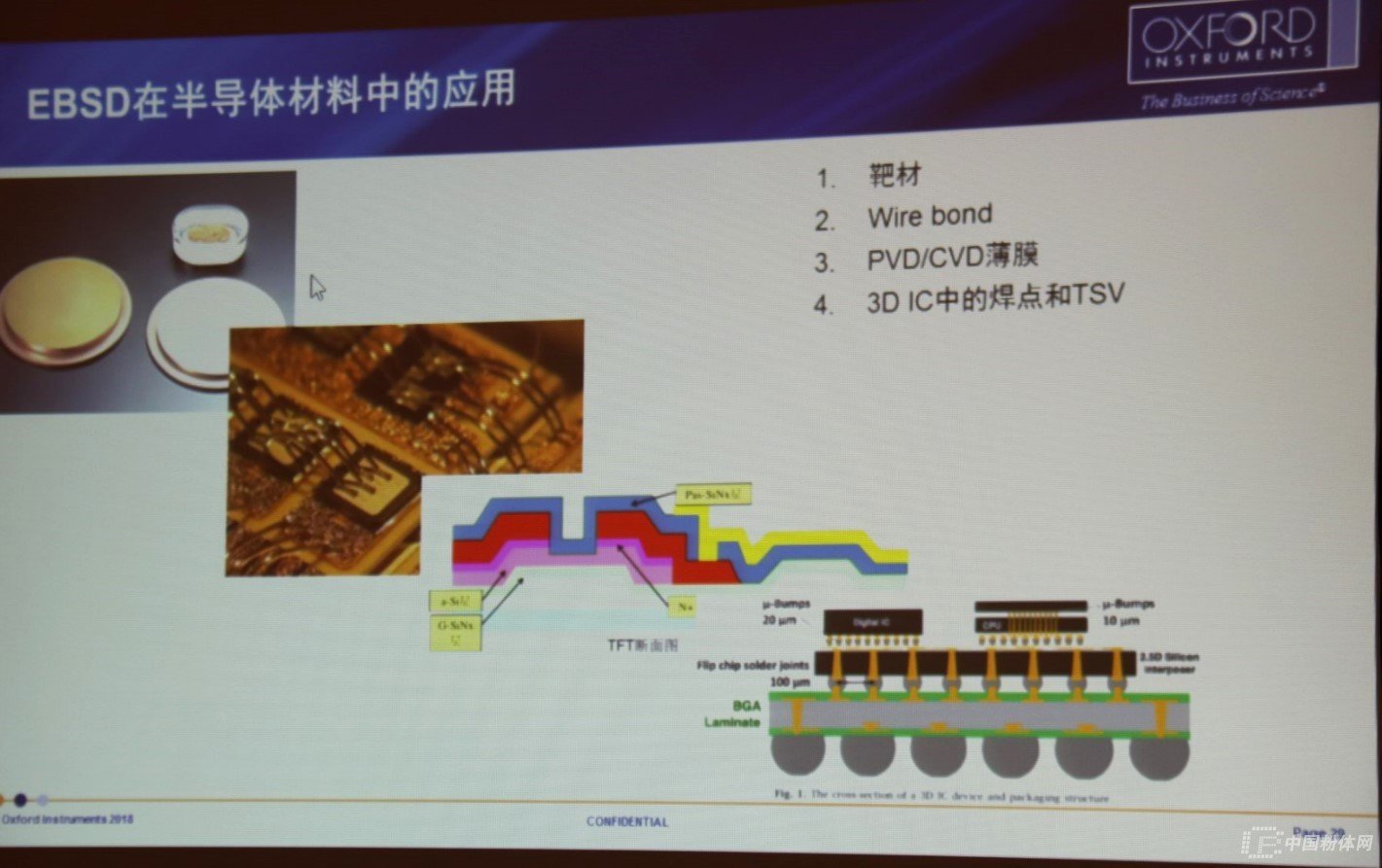





周海鑫:《日立SEM和FIB在半导体和新材料领域的最新应用和进展》